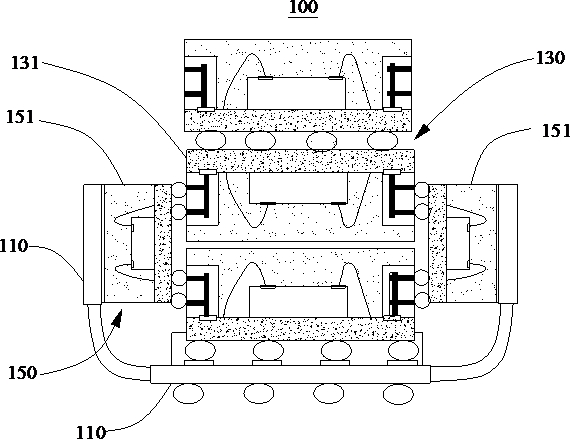
技术摘要:
本发明的实施例提供了一种柔性基板堆叠封装结构和柔性基板堆叠封装方法,涉及芯片封装技术领域,该柔性基板堆叠封装结构和柔性基板堆叠封装方法,通过在柔性基板的侧翼贴装第二器件封装组件,第二器件封装组件与柔性基板电气隔离,且第二器件通过与第一器件封装组件电 全部
背景技术:
随着半导体行业的快速发展,电子产品微型化越来越高密度,功能越来越多,产品 尺寸越来越小,锡球与锡球之间的距离越来越小,因此,POP(Package on Package)堆叠结 构广泛应用于半导体行业中。以及采用柔性基板堆叠结构与POP产品堆叠结合,它将不同功 能芯片封装后,进行堆叠,主要优势为高密度集成,封装产品尺寸小,产品性能优越,大幅利 用堆叠空间。 现有技术中,柔性基板侧翼IC器件需要与柔性基板侧翼线路相连,为了实现侧翼 堆叠,此时需要在柔性基板侧翼上布线路层,再将IC器件与线路层电连接,而在进行柔性基 板折弯侧翼时,存在折弯线路层损坏的风险,导致产品叠装失效。
技术实现要素:
本发明的目的包括,例如,提供了一种柔性基板堆叠封装结构和柔性基板堆叠封 装方法,其能够避免柔性基板折弯导致线路失效的风险。 本发明的实施例可以这样实现: 第一方面,本发明实施例提供一种柔性基板堆叠封装结构,包括: 柔性基板; 贴装在所述柔性基板的中部,并与所述柔性基板电连接的第一器件封装组件; 绝缘贴装在所述柔性基板的侧翼的第二器件封装组件; 其中,所述柔性基板的侧翼向上翻折设置并使得所述第二器件封装组件贴装在所述第 一器件封装组件的侧壁,且所述第二器件封装组件与所述第一器件封装组件电连接。 在可选的实施方式中,所述第一器件封装组件包括多个依次向上堆叠的正装IC器 件,底部的所述正装IC器件贴装在所述柔性基板上并与所述柔性基板电连接,每相邻两个 正装IC器件反向堆叠,所述第二器件封装组件至少与底部的两个相邻的所述正装IC器件电 连接。 在可选的实施方式中,多个所述正装IC器件包括第一IC器件和第二IC器件,所述 第一IC器件贴装在所述柔性基板的中部,并与所述柔性基板电连接,所述第二IC器件堆叠 在所述第一IC器件上,所述第二器件封装组件分别与所述第一IC器件和所述第二IC器件电 连接。 在可选的实施方式中,多个所述正装IC器件还包括第三IC器件,所述第二IC器件 倒置堆叠在所述第一IC器件上,所述第三IC器件堆叠在所述第二IC器件上,并与所述第二 IC器件电连接。 在可选的实施方式中,所述第三IC器件与所述第二IC器件之间、所述第一IC器件 4 CN 111599797 A 说 明 书 2/9 页 与所述柔性基板之间均通过锡球焊接,并填充有包覆胶层。 在可选的实施方式中,所述正装IC器件包括第一IC基板、第一芯片和第一塑封体, 所述第一IC基板贴装在所述柔性基板或相邻的所述第一IC基板上,所述第一芯片贴装在所 述第一IC基板上,并与所述第一IC基板电连接,所述第一IC基板的边缘还设置有导电柱,所 述导电柱用于连接所述第二器件封装组件。所述第一塑封体设置在所述第一IC基板上并包 覆在所述第一芯片外,且所述第一塑封体粘接在相邻的所述第一塑封体上。 在可选的实施方式中,所述第二器件封装组件包括至少一个所述侧装IC器件,所 述侧装IC器件的一侧贴装在所述柔性基板的侧翼,另一侧贴装在相邻两个所述正装IC器件 的侧壁,并与相邻的两个所述正装IC器件电连接。 在可选的实施方式中,所述侧装IC器件包括第二IC基板、第二芯片和第二塑封体, 所述第二芯片贴装在所述第二IC基板上,并与所述第二IC基板电连接,所述第二塑封体设 置在所述第二IC基板上并包覆在所述第二芯片外,且所述第二塑封体粘接在所述柔性基板 的侧翼,所述第二IC基板贴装在相邻两个所述正装IC器件的侧壁,并与相邻的两个所述正 装IC器件电连接。 在可选的实施方式中,所述第二器件封装组件为两个,两个所述第二器件封装组 件分别贴装在所述第一器件封装组件的两侧。 第二方面,本发明实施例提供一种柔性基板堆叠封装方法,包括以下步骤: 将第一器件封装组件贴装在所述柔性基板的中部; 将第二器件封装组件绝缘贴装在所述柔性基板的侧翼; 将所述柔性基板的侧翼向上翻折,并使得所述第二器件封装组件贴装在所述第一器件 封装组件的侧壁; 其中,所述第二器件封装组件与所述第一器件封装组件电连接。 在可选的实施方式中,将第一器件封装组件贴装在所述柔性基板的中部的步骤, 包括: 制备正装IC器件; 将多个所述正装IC器件依次堆叠在所述柔性基板的中部,以形成所述第一器件封装组 件; 其中,每相邻两个所述正装IC器件反向堆叠。 在可选的实施方式中,制备正装IC器件的步骤,包括: 在第一IC基板上形成导电柱; 将第一芯片贴装在所述第一IC基板上; 在所述第一IC基板上形成包覆在所述第一芯片外的第一塑封体; 在所述第一IC基板的背面植球,以制备形成所述正装IC器件。 在可选的实施方式中,将多个所述正装IC器件依次堆叠在所述柔性基板的中部, 以形成所述第一器件封装组件的步骤,包括: 将第一IC器件贴装在所述柔性基板的中部; 在所述第一IC器件上倒置堆叠第二IC器件; 在所述第二IC器件上堆叠第三IC器件; 其中,所述第二IC器件与所述第一IC器件粘接,所述第三IC器件与所述第二IC器件通 5 CN 111599797 A 说 明 书 3/9 页 过锡球焊接。 本发明实施例的有益效果包括,例如: 本发明提供的一种柔性基板堆叠封装结构,通过在柔性基板的侧翼贴装第二器件封装 组件,第二器件封装组件与柔性基板电气隔离,且第二器件通过与第一器件封装组件电连 接实现电气连接功能,避免了在柔性基板上布置线路层,进而避免了由于柔性基板折弯导 致线路层失效的问题,保证了堆叠的有效性和稳定性。 附图说明 为了更清楚地说明本发明实施例的技术方案,下面将对实施例中所需要使用的附 图作简单地介绍,应当理解,以下附图仅示出了本发明的某些实施例,因此不应被看作是对 范围的限定,对于本领域普通技术人员来讲,在不付出创造性劳动的前提下,还可以根据这 些附图获得其他相关的附图。 图1为本发明第一实施例提供的柔性基板堆叠封装结构的最终状态的结构示意 图; 图2为本发明第一实施例提供的柔性基板堆叠封装结构的中间步骤的结构示意图; 图3为图1中正装IC器件的结构示意图; 图4为图1中侧装IC器件的结构示意图; 图5为本发明第二实施例提供的柔性基板堆叠封装方法的步骤框图; 图6-图16为本发明第二实施例提供的柔性基板堆叠封装方法中制备第一IC基板的工 艺流程图; 图17-图19为本发明第二实施例提供的柔性基板堆叠封装方法的工艺步骤流程图。 图标:100-柔性基板堆叠封装结构;110-柔性基板;130-第一器件封装组件;131- 正装IC器件;131a-第一IC基板;131b-第一芯片;131c-第一塑封体;131d-导电柱;131e-树 脂层;131f-侧装焊盘;133-第一IC器件;135-第二IC器件;137-第三IC器件;139-包覆胶层; 150-第二器件封装组件;151-侧装IC器件;153-第二IC基板;153a-侧装锡球;155-第二芯 片;157-第二塑封体。












