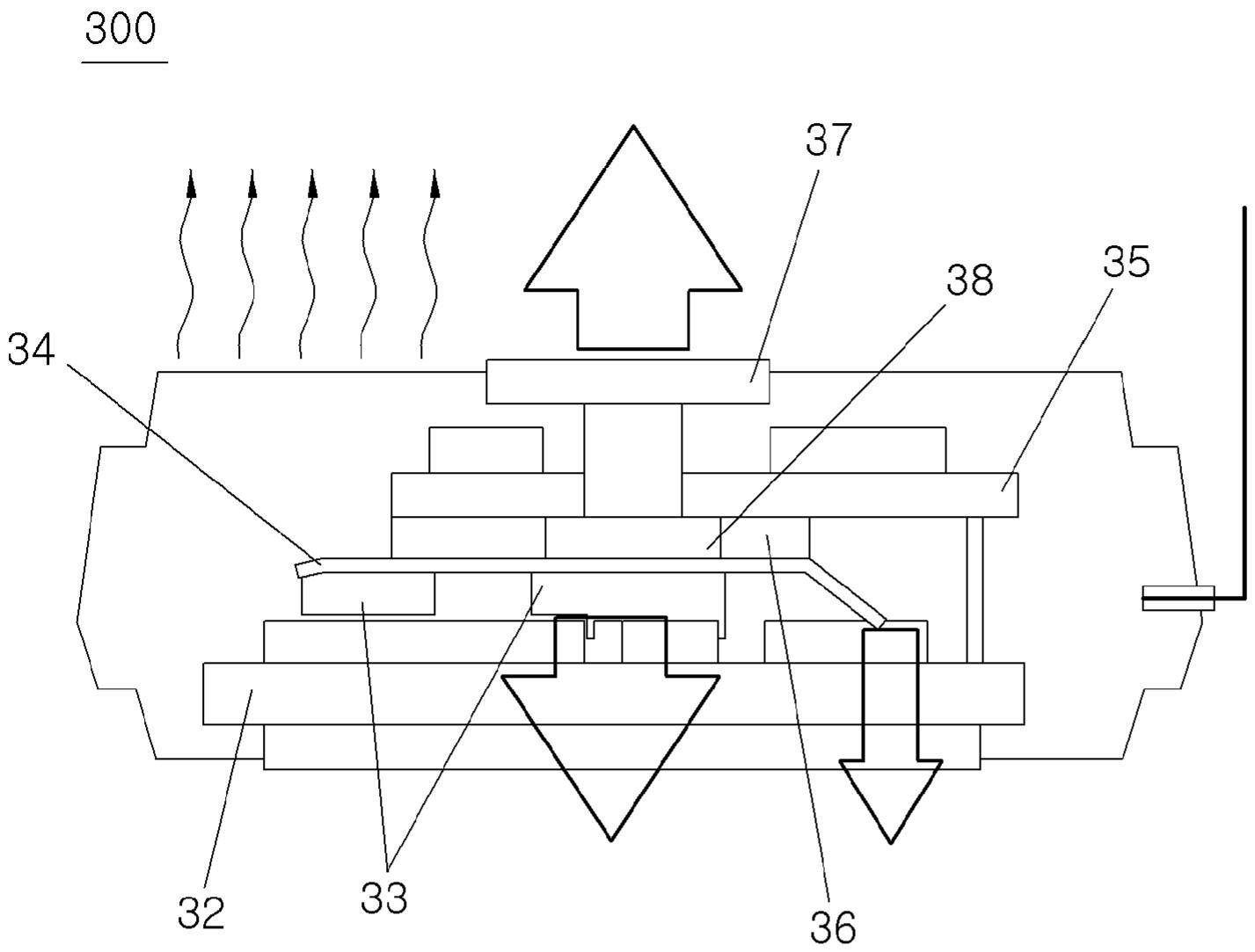
技术摘要:
本发明涉及一种功率半导体模块,该功率半导体模块包括:第一散热衬底;半导体芯片;引线板;PCB;以及散热器,该第一散热衬底、半导体芯片、引线板、PCB以及散热器被封装在壳体中。由于散热结构被双重应用,因此与常规技术相比,该功率半导体模块可以展现出优异的散热 全部
背景技术:
功率半导体模块是通过使功率半导体芯片作为封装件中的模块而被优化以进行 功率转换或控制的半导体模块。特别地,绝缘栅双极型晶体管(IGBT)是一种类型的功率半 导体,并且是用于高功率开关的半导体。 阻挡或允许电流流动的开关功能可通过其他部件或电路实现。然而,要求精确运 作的产品需要运作速度快且功率损耗低的专用部件。 然而,作为开关半导体的晶体管具有较高的生产率,但是其电路构造复杂且运作 速度慢。MOSFET的功耗低且运作速度快,但是成本较高。IGBT是只有晶体管与MOSFET的优点 的结合。 包括IGBT模块等的功率半导体模块具有如下结构:在该结构中,衬底被放置在基 板上并且半导体芯片被放置在衬底上。 在此,半导体芯片通过与由铝材料制成的导线键合而电连接至衬底,此外,衬底具 有通过导线键合而连接至PCB的结构。热阻对散热特性非常重要。关于每种材料的热阻(以 W/m-K为单位),作为陶瓷衬底的AIN衬底的热阻为180W/m-K;Al2O3的热阻为21W/m-K;Si3N4 的热阻为80W/m-K;作为金属的铜(Cu)的热阻为390W/m-K;焊料的热阻为35W/m-K至60W/m- K;半导体芯片的掺杂硅(掺杂Si)的热阻约为70W/m-K。因此,需要进一步研究以解决功率半 导体模块的发热问题。 图1和图2示出了常规的功率半导体模块。 如图1所示,功率半导体模块100具有如下结构:在该结构中,IGBT 11A和二极管 11B被附接在衬底10上;键合导线13连接IGBT 11A、二极管11B和控制IC 11C;被布置在旁边 的PCB 12通过引线框15连接;并且这些元件被封装在壳体中。 另外,如图2所示,功率半导体模块200具有封装结构,在该封装结构中,基板23通 过导热油脂22形成在散热器21上;基板23经由下部基板焊料24附接到衬底28上;IGBT 26A 和二极管26B经由上部芯片焊料25附接到衬底28上;IGBT 26A和二极管26B通过引线框27连 接。 图1和图2的功率半导体模块使热量通过设置在基板下表面的下方的散热器等消 散。然而,在这些结构中,热量仅沿一个方向消散,使得在将热量从功率半导体模块中消散 方面存在限制。因此,需要进一步研究以改善散热结构。在专利文献1中,公开了一种常规的 功率半导体模块。 在该
技术实现要素:
部分中公开的上述信息仅用于加强对本发明的












