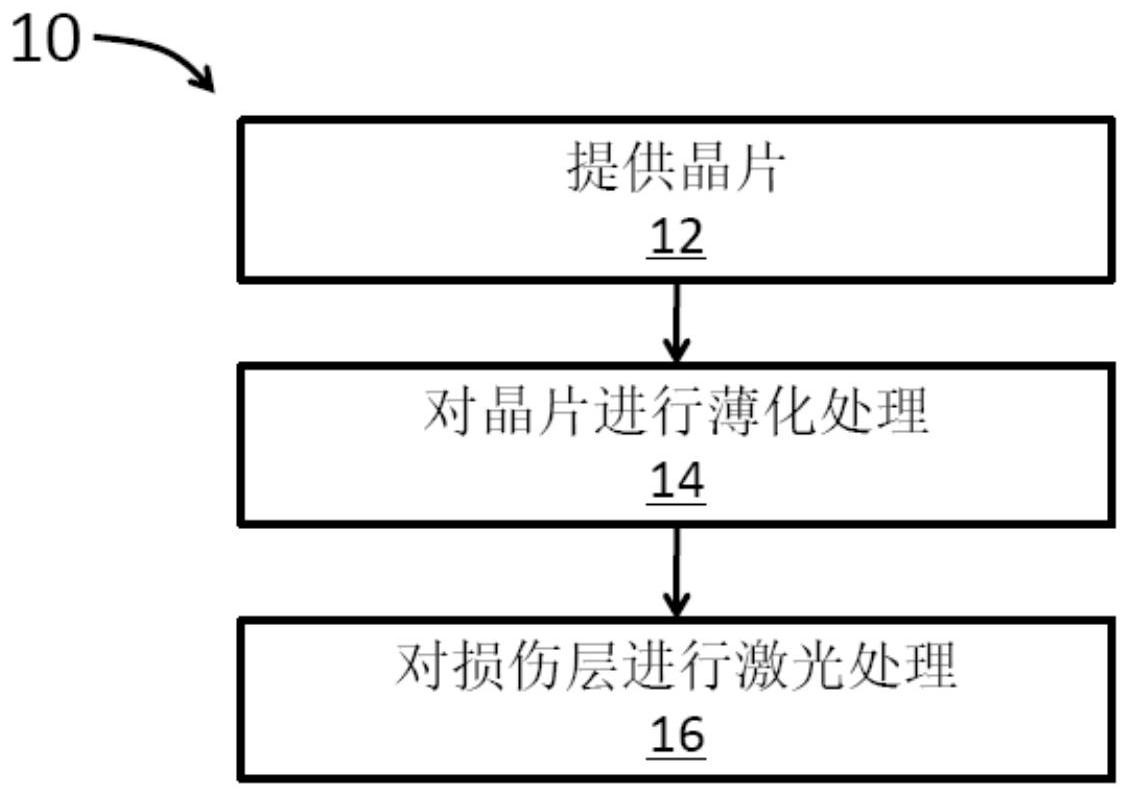
技术摘要:
本发明提供了晶片加工方法及半导体装置。示例性晶片加工方法包括:提供晶片,晶片具有第一侧和与第一侧相对的第二侧,晶片包括单晶态的半导体材料;对第二侧进行薄化处理,以使得经薄化处理的第二侧产生损伤层;以及对损伤层进行激光处理,以使得损伤层的半导体材料转 全部
背景技术:
半导体器件、或集成电路通常在半导体基体或基板(例如晶片)上制造。例如,大部 分半导体器件是在半导体基体的浅表面层上制造。由于制造工艺本身的复杂,比如可达几 百道工艺流程,通常不可采用较薄的晶片,而是只能采用一定厚度的晶片在工艺过程中传 递、流片。通常在半导体器件封装前,需要对晶片背面多余的基体材料去除一定的厚度。 为达到减薄的目的,通常对晶片背面进行研磨。研磨会对背面层产生损伤,例如产 生裂纹和翘曲等,这对器件性能不利。为此,对于硅基晶片而言,通常会用化学方法蚀刻掉 该损伤层。但是对于一些半导体材料,例如碳化硅(SiC)基体,由于碳化硅本身的材料特性 (例如硬度十分大等),用化学方法蚀刻需要非常显著的更长时间,并且效果也不理想,这不 但影响器件性能,而且也极大地增加了制造周期,进而增加了半导体芯片的制造成本。
技术实现要素:
本发明提供了晶片加工方法及半导体装置,以解决现有技术中存在的上述技术问 题中的一个或多个。 根据本发明的一方面,提供了一种晶片加工方法,包括:提供晶片,晶片具有第一 侧和与第一侧相对的第二侧,晶片包括单晶态的半导体材料;对第二侧进行薄化处理,以使 得在经薄化处理的第二侧产生损伤层;以及对损伤层进行激光处理,以使得损伤层的半导 体材料转变成多晶态。 根据本发明的另一方面,提供了一种晶片加工方法,包括:提供包含碳化硅的晶 片,晶片具有第一侧和与第一侧相对的第二侧,并且具有第一厚度;在第一侧上设置半导体 器件;对第二侧进行研磨,以使得晶片从第一厚度减薄至第二厚度,并且在第二侧产生损伤 层;对损伤层进行激光处理,以使得损伤层的碳化硅转变成多晶态的碳化硅;以及去除损伤 层,以使得晶片从第二厚度减薄至第三厚度。 根据本发明的又一方面,提供了一种半导体装置,该半导体装置包括根据本发明 的实施例的晶片加工方法得到的晶片以及在晶片的第一侧上设置的半导体器件。 与现有技术相比,本发明具有许多优点。例如,根据本发明的实施例的晶片加工方 法简单、便捷,可使得晶片薄化过程中产生的损伤层容易、快速、有效去除,不但有利于器件 性能,而且加快了芯片制造进程、缩短了芯片制造周期,从而降低了生产成本以及采用了该 方法的半导体装置的制造成本。 关于本发明的其他实施例和更多技术效果将在下文详述。 附图说明 现在将参考附图以示例的方式描述本发明的实施例。一个或多个实施例通过与之 3 CN 111599670 A 说 明 书 2/4 页 对应的附图中的图片进行示例性说明,这些示例性说明并不构成对实施例的限定。为方便 计,相同或相似的元件在附图中采用相同或相似的附图标记,除非有特别申明,附图中的图 不构成比例限制。 图1是根据本发明一实施例的晶片加工方法的流程图; 图2a-2d是根据本发明一实施例的晶片加工方法的示意图; 图3示出根据本发明另一实施例的晶片加工方法的流程图。












