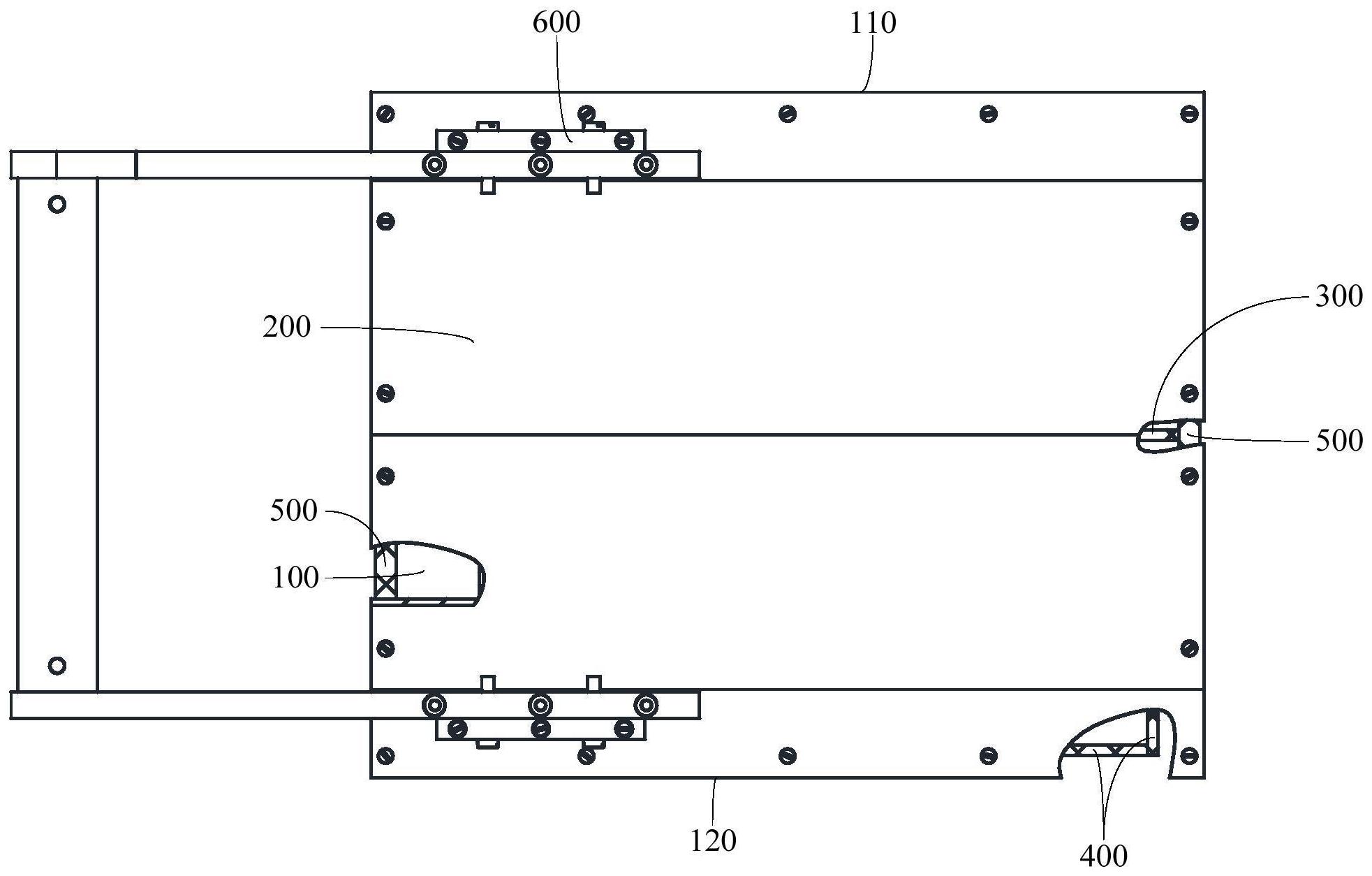
技术摘要:
本发明公开一种槽式清洗设备的密封盖及槽式清洗设备,所述密封盖用于密封所述槽式清洗设备的清洗槽,所述密封盖包括密封盖本体(100)、密封膜(200)和支撑件(300);所述支撑件(300)设置于所述密封盖本体(100)上,且所述支撑件(300)凸起于所述密封盖本体(100)背离所述清洗 全部
背景技术:
在半导体加工的过程中,晶圆表面的清洁度是影响半导体器件可靠性的重要因素 之一,而在晶圆的加工过程中,沉积、等离子体刻蚀、旋涂光刻胶、光刻、电镀等加工方式均 有可能导致晶圆表面引入污染或颗粒,导致晶圆表面的清洁度下降,致使采用该晶圆制造 的半导体器件的良率低,因此在晶圆加工结束后需要利用清洗设备对晶圆进行清洗。 目前,晶圆一般利用槽式清洗设备进行清洗,槽式清洗设备一般分为若干个清洗 槽,每个清洗槽均采用气动式密封盖,密封盖可有效防止清洗过程中清洗液的挥发,还能够 防止清洗过程中污染物(例如灰尘、水、化学药液等)进入清洗槽,造成清洗槽中清洗液受到 污染,影响晶圆清洗的成功率。但是,目前的密封盖为矩形围栏式结构,只有在污染液体集 满此密封盖时,污染液体才能够流入排污区,导致密封盖承载的污染液体重量较大,容易造 成密封盖上的密封膜破坏,从而导致密封盖失效。同时,当污染液体集满整个密封盖时,此 时利用气缸打开密封盖,会对气缸产生巨大的冲击力,造成气缸超负荷工作,对气缸产生破 坏,且在密封盖开启的过程中,虽然槽式清洗设备设置有排污口,但此时污染液体的量超过 排污口的承载量,过多的污染液体会流入清洗槽内,造成清洗槽内清洗液污染,影响冲洗效 果。
技术实现要素:
本发明公开一种槽式清洗设备的密封盖及槽式清洗设备,能够解决密封盖积液较 多而导致气缸、密封盖容易损坏以及污染液体流入清洗槽的问题。 为了解决上述问题,本发明采用下述技术方案: 一种槽式清洗设备的密封盖,用于密封槽式清洗设备的清洗槽,所述密封盖包括 密封盖本体、密封膜和支撑件; 所述支撑件设置于所述密封盖本体上,且所述支撑件凸起于所述密封盖本体背离 所述清洗槽的一侧,所述密封膜覆盖所述密封盖本体背离所述清洗槽的一侧,且所述支撑 件支撑所述密封膜,以使所述密封膜形成导流斜面。 一种槽式清洗设备,包括清洗槽和上述密封盖,所述密封盖可密封所述清洗槽。 本发明采用的技术方案能够达到以下有益效果: 本发明实施例公开的槽式清洗设备的密封盖及槽式清洗设备中,支撑件设置于密 封盖本体,且支撑件凸起于密封盖本体背离清洗槽的一侧,密封膜覆盖密封盖本体背离清 洗槽的一侧,且支撑件支撑密封膜,以使密封膜形成导流斜面。在具体的工作过程中,当污 染液体滴落到导流斜面上时,污染液体在重力的作用下,污染液体能够顺着导流斜面快速 地流走,防止污染液体在密封盖上积存,相较于目前矩形围栏式结构的密封盖,本发明实施 3 CN 111589781 A 说 明 书 2/6 页 例公开的密封盖不积液,从而能够使得密封盖承载的污染液体重量较小,防止密封盖上的 密封膜因污染液体的重量较大而破坏,进而避免密封盖的损坏,进而能够提高密封盖的可 靠性。 与此同时,在密封盖不积液的情况下,此时利用气缸等驱动机构打开密封盖时,密 封盖对驱动机构产生的冲击力较小,从而防止驱动机构超负荷工作,避免对驱动机构产生 破坏,且在密封盖开启的过程中,由于本发明实施例公开的密封盖不积液,从而使得污染液 体通过导流斜面及时流走,污染液体最终会沿着密封膜的边缘流向排污区,从而使得污染 液体从排污区的排污口排出槽式清洗设备,防止污染液体的量超过排污口的承载量,导致 过多的污染液体流入清洗槽内,从而避免清洗槽内清洗液的污染,影响晶圆的清洗效果。 附图说明 为了更清楚地说明本发明实施例或












