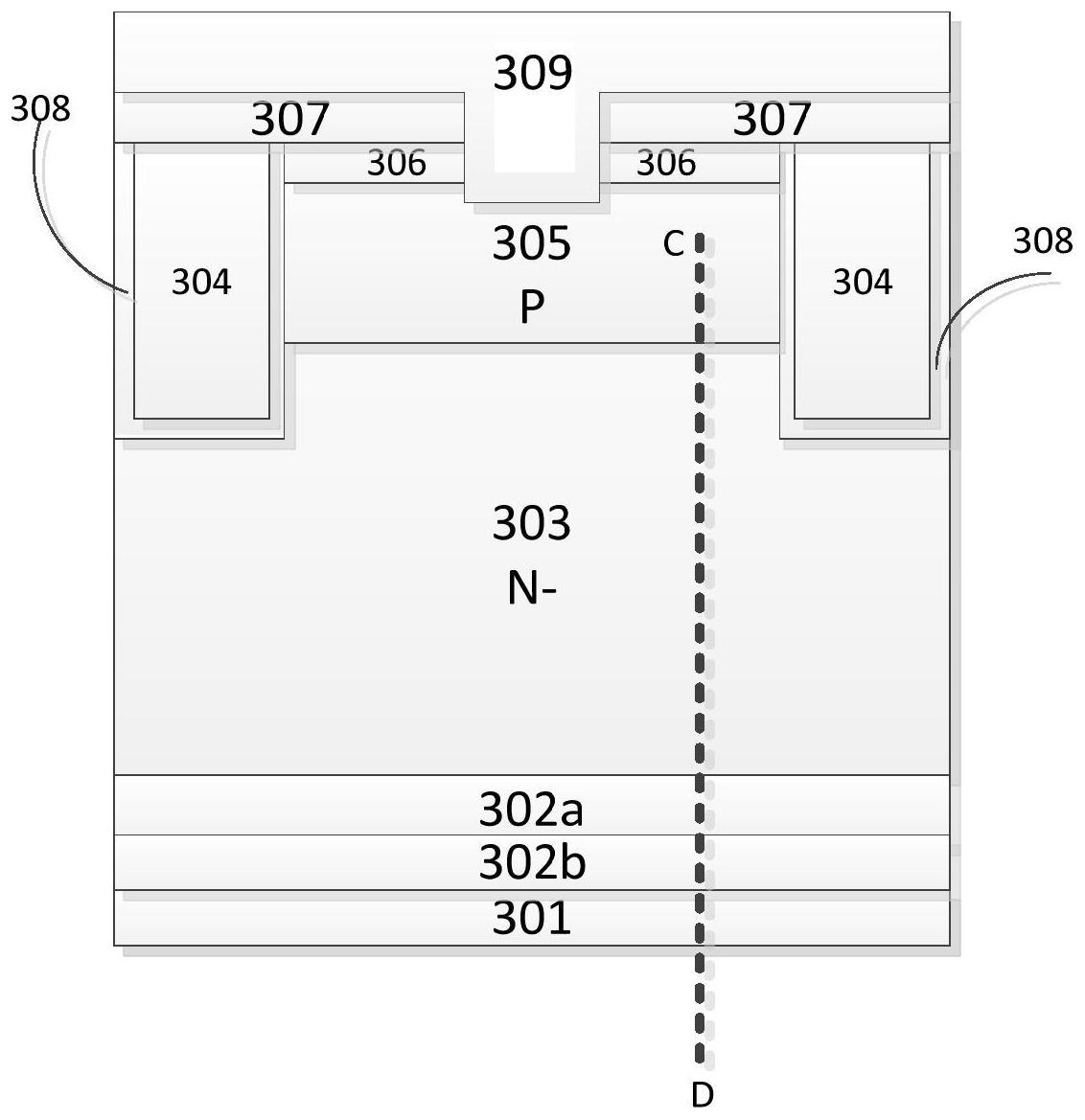
技术摘要:
本发明公开了一种高性能半导体功率器件,包括P型集电区、N型场终止层、N型漂移区、IGBT的正面元胞结构,所述N型场终止层的结构为由多个子场终止层组成的多层结构,每层之间掺杂浓度各不相同。本发明的优点在于:解决了现有技术中的FS‑IGBT的缺陷,变掺杂场终止结构, 全部
背景技术:
绝缘栅双极型晶体管(简称IGBT)一种性能优异的半导体功率器件,综合了MOSFET 的电压控制型期间和三极管双极型导通特性的优点,具有导通压降低,功率频率高,控制电 路简单的优点。自上世纪80年代发明以来,IGBT技术经过了长足的发展,现有主流的IGBT均 为场终止型IGBT(简称FS-IGBT)。 如图1为现有FS-IGBT典型结构示意图,从背面到正面,依次是101为P型集电区, 102N型场终止层,103N型漂移区,104~109组成的IGBT的正面元胞结构,包括沟槽栅104,P 型阱区105,N型源区106,绝缘介质107和108,发射极电极(E)109。 现有FS-IGBT的特点是:101区为掺杂浓度高达1E18/cm3的P型集电区,厚度小于 1um。103的掺杂浓度通常为1e12/cm3~1e14/cm3,厚度根据耐压要求不同,从几十um只几百 um不等。102场终止层的功能是在IGBT承受高压时,利用其杂质形成的电荷,将电场终止,另 外,在IGBT关断过程中,102区域内留存有一定数量的空穴载流子,确保关断存在一定的电 流拖尾,实现软关断过程,避免过高的电压尖峰。102的掺杂浓度结余101和103之间,通常为 为1e14/cm3至1e18/cm3范围,通常是均匀掺杂或者从靠近101区到近103区浓度呈一定的下 降趋势的分布,厚度从2um~30um范围不等,通常厚度约薄的场终止层,掺杂浓度越高。 如图2,为图1中沿AB虚线处界的掺杂浓度分布以及承受高压时的电场分布示意 图。可见在承受高压时,电场在102层场终止层内下降为零,102区存在部分未被电场耗尽的 区域。正是102区未耗尽区域的存在,才保证了在IGBT关断末期仍然保留有部分过剩的空穴 载流子,维持了电流拖尾,未耗尽区域越宽,电流拖尾越大时间越长,关断损耗越大,未耗尽 区域越小,电流拖尾小时间段,电流下降快,关断损耗低,电压尖峰越高。针对某一应用的工 作电压,可以设计适当的102层厚度和掺杂浓度,使关断软度和关断损耗再一个最优的接受 值。但是,往往对于一个特定的IGBT器件,其实际的工作电压往往是一个很大的范围,例如 (1200V IGBT,通常在400V~800V的电压范围内都有可能应用),在较低电压下工作时,未耗 尽区域宽,电流拖尾长,损耗大,系统效率无法达到最优。在较高电压下工作时,电流下降 快,过冲电压高,过压失效的风险大幅度提升。因此,现有FS-IGBT芯片性能存在局限。
技术实现要素:
本发明的目的在于克服现有技术的不足,提供一种高性能半导体功率器件及其制 造方法,用于使得半导体器件可以在较低电压下工作时以及较高电压下工作时均能表现出 良好的性能。 为了实现上述目的,本发明采用的技术方案为:一种高性能半导体功率器件,包括 P型集电区、N型场终止层、N型漂移区、IGBT的正面元胞结构,所述N型场终止层的结构为由 3 CN 111725312 A 说 明 书 2/4 页 多个子场终止层组成的多层结构,每层之间掺杂浓度各不相同。 所述N型场终止层的多层结构中,在由P型集电区至N型漂移区的方向上依次设置 子场终止层。 所述多层结构中包括用于实现不同电压下的场终止功能的子场终止层a、用于保 证关断软度的子场终止层b,其中子场终止层a的掺杂浓度大于N型漂移区以及子场终止层b 的掺杂浓度。 所述多层结构还包括用于实现低关断损耗的子场终止层c,其中子场终止层b的掺 杂浓度低于子场终止层a以及子场终止层c,子场终止层的掺杂浓度高于子场终止层a和b的 掺杂浓度且低于p型集电区的掺杂浓度。 子场终止层的分布结构分别为沿N型漂移区至P型集电区方向上依次设置子场终 止层a、子场终止层b、子场终止层c。 所述多层结构为三层。 一种高性能半导体功率器件的制造方法,包括步骤: 步骤1:在N型掺杂的半导体衬底的正面形成正面元胞结构; 步骤2:在半导体衬底的背面根据耐压要求设置子场终止层的厚度和掺杂浓度; 步骤3:通过高能离子注入和退火,依次形成场终止层的多层结构并形成底部的p 型集电区; 步骤4:在背面形成金属电极。 本发明的优点在于:解决了现有技术中的FS-IGBT的缺陷,变掺杂场终止结构,电 场终止和关断软度的保证可以进行独立的控制,故而能够保证IGBT在较宽的电压范围内, 维持稳定的低关断损耗和高关断软度特性,保证足够的关断软度同时,实现低关断损耗。 附图说明 下面对本发明说明书各幅附图表达的内容及图中的标记作简要说明: 图1为现有FS-IGBT典型结构示意图 图2为图1中沿AB虚线处界的掺杂浓度分布以及承受高压时的电场分布示意图; 图3为本发明两层结构的场终止层的IGBT结构示意图; 图4为沿图3中CD虚线切面的掺杂浓度和承受高压时的电场分布示意图; 图5为三层结构场终止层的半导体FS-IGBT的结构示意图; 图6为图5中沿EF切面的掺杂浓度和电场分布示意图。












