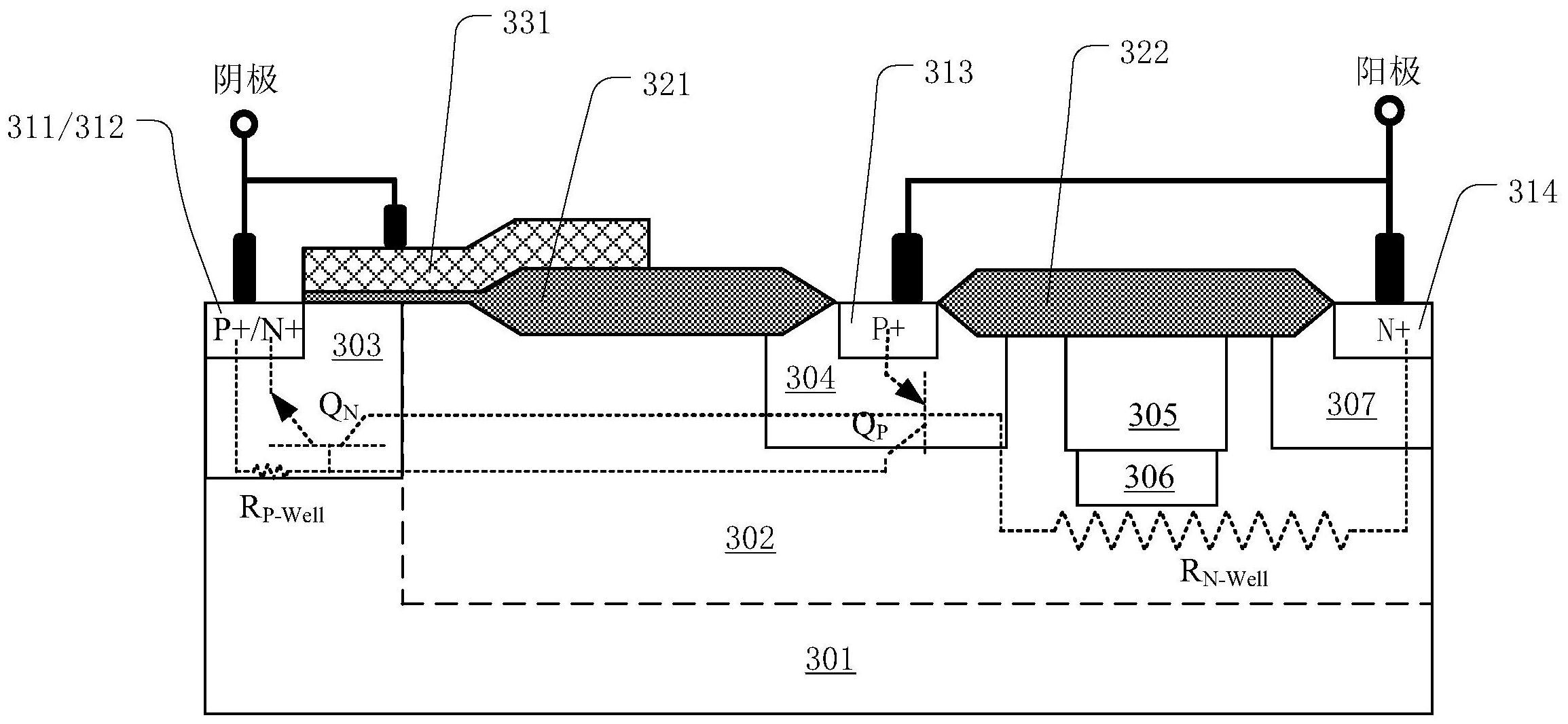
技术摘要:
本发明公开了一种用于静电防护的晶体管结构及其制造方法,晶体管结构包括:衬底;形成于衬底上部的漂移区;形成于衬底表面的多个场氧化层;形成于衬底上部的第一P型阱区;形成于漂移区上部的依次隔开的第一N型阱区、第二P型阱区和第二N型阱区;形成于衬底表面上的且覆 全部
背景技术:
静电放电ESD(Electro-Static Discharge)是日常生活中的常见现象,虽不易被 人体感知,却会对集成电路产品造成严重威胁。对于高压CMOS或高压BCD(Bipolar CMOS DMOS,双极性CMOS DMOS)工艺,其广泛的用于制造电源管理、高压驱动以及汽车电子等领域 的集成电路产品中。而这类集成电路产品往往工作在大电流、大电压、强电磁干扰环境下, ESD防护器件会出现低鲁棒性、误触发等问题,需要高可靠、高鲁棒性的ESD解决防护方案。 静电放电现象的模式通常分为几种:HBM(人体放电模式),MM(机器放电模式),CDM (组件充电放电模式)。相比于HBM,MM是带静电的机器触碰到芯片某管脚然后对地放电,CDM 是自身带静电荷的芯片某管脚接触到地,从而引起芯片内部的静电荷转移到地的ESD模式。 由于MM和CDM模式下的放电回路总电阻很小,因此波形的上升速度非常快,尤其对于CDM放 电,约为0.2~0.4ns,脉冲持续时间约为5ns。 如图1所示,为传统的LDMOS(Lateral Double Diffused MOS Transistor,横向双 扩散绝缘栅场效应晶体管)的结构图,主要包括:衬底101和位于衬底101上部的P型阱区103 和漂移区102,在漂移区102上部形成有N型阱区104,在P型阱区103中形成有P 区域105和第 一N 区域106,在N型阱区104中形成有第二N 区域107,在衬底101表面形成有第一栅氧层 111、第二栅氧层112和场板121,场板121位于第一N 区域106和第二N 区域107之间。P 区域 105、第一N 区域106和场板121连接阴极,第二N 区域107连接阴极。在此结构基础上,当ESD 脉冲来临时,LDMOS器件寄生NPN管存在开启的非均匀性问题,会导致局部电流聚积,电子电 流密度超过漂移区杂质浓度后,电场峰值转移到近漏端,LDMOS内部发生内部kirk(基区扩 展效应),局部过热失效。 因此,有必要提供改进的技术方案以克服现有技术中存在的以上技术问题。
技术实现要素:
为了解决上述技术问题,本发明提供了一种用于静电防护的晶体管结构及其制造 方法,可以保证在ESD电压来临时器件SCR路径中寄生的PNP结构先开启,消除了器件内部的 基区扩展效应,使得器件在超快静电脉冲下仍具有有效的防护作用。 根据本发明提供的一种用于静电防护的晶体管结构,包括:衬底;形成于所述衬底 上部的漂移区;形成于所述衬底表面的多个场氧化层;形成于所述衬底上部的第一P型阱 区;形成于所述漂移区上部的依次隔开的第一N型阱区、第二P型阱区和第二N型阱区;形成 于所述衬底表面上的且覆盖部分所述第一P型阱区的多晶硅层;形成于所述第一P型阱区中 的第一P 区域和第一N 区域;以及分别形成于所述第一N型阱区和所述第二N型阱区中的第 二P 区域和第二N 区域,其中,所述晶体管结构还包括形成与所述第一N型阱区和所述第二 4 CN 111584481 A 说 明 书 2/7 页 N型阱区之间的第三P型阱区。 优选地,所述第二P阱与所述第三P阱区位于同一竖直方向,且所述第二P阱与所述 第三P阱的深度不同、宽度不同。 优选地,所述第一P 区域嵌入于所述第一N 区域中。 优选地,所述第一P 区域的版图形状为圆形。 优选地,所述第一P 区域、所述第一N 区域和所述多晶硅层相连接,其连接端作为 所述晶体管结构的阴极;所述第二P 区域和所述第二N 区域相连接,其连接端作为所述晶 体管结构的阳极。 优选地,所述漂移区为浅掺杂的N型区域。 优选地,所述多个场氧化层包括形成于所述第一P 区域和所述第二P 区域之间的 第一场氧化层,以及形成于所述第二P 区域和所述第二N 区域之间的第二场氧化层。 根据本发明提供的一种用于静电防护的晶体管结构的制造方法,包括:形成衬底; 在所述衬底上部形成漂移区;在所述衬底表面形成多个场氧化层;形成位于所述衬底上部 的第一P型阱区;形成位于所述漂移区上部的依次隔开的第一N型阱区、第二P型阱区和第二 N型阱区;形成位于所述衬底表面上且覆盖部分所述第一P型阱区的多晶硅层;形成位于所 述第一P型阱区中的第一P 区域和第一N 区域;以及分别形成位于所述第一N型阱区和所述 第二N型阱区中的第二P 区域和第二N 区域,其中,所述制造方法还包括形成位于所述第一 N型阱区和所述第二N型阱区之间的第三P型阱区。 优选地,所述第二P阱与所述第三P阱区位于同一竖直方向,且所述第二P阱与所述 第三P阱的深度不同、宽度不同。 优选地,所述第一P 区域的版图形状为圆形,且所述第一P 区域嵌入于所述第一N 区域中。 本发明的有益效果是:本发明公开了一种用于静电防护的晶体管结构及其制造方 法,通过将可控硅器件的漏端的P 区域和N 区域拉开并分别放在两个N型阱区中,增大了电 子的漂移距离(电子从第一P型阱区流入第二N型阱区),通过在两个N型阱区之间注入两个 位于同一垂直线上的P型阱区,进一步增大了电子的漂移距离,同时也大大增加了N型阱区 的寄生电阻,使得器件能够以较小的电流就形成开启寄生PNP结构的压降,有效的保证了器 件中的寄生PNP结构先开启。 同时,在源端的P型阱区采用圆形P 区域嵌入N 区域,使得在不影响N 区域引出的 情况下,有效的降低了源端P型阱区的寄生电阻,防止了器件中寄生的NPN结构先开启,进一 步保证了在ESD电压来临时器件SCR路径中寄生的PNP结构先开启,继而带动寄生的NPN结构 开启,消除了器件内部的基区扩展效应,使得器件在超快静电脉冲下仍具有有效的防护作 用。 应当说明的是,以上的一般描述和后文的细节描述仅是示例性和解释性的,并不 能限制本发明。 附图说明 通过以下参照附图对本发明实施例的描述,本发明的上述以及其他目的、特征和 优点将更为清楚。 5 CN 111584481 A 说 明 书 3/7 页 图1示出现有技术的用于静电防护的LDMOS器件结构的截面示意图; 图2示出用于静电防护的LDMOS-SCR器件结构的截面示意图; 图3示出用于静电防护的LDMOS-SCR器件结构的等效电路图; 图4示出根据本发明实施例的用于静电防护的晶体管结构的截面示意图; 图5示出根据本发明实施例的用于静电防护的晶体管结构的版图示意图; 图6a至图6e示出根据本发明实施例的用于静电防护的晶体管结构的制造方法的 各个阶段的截面示意图。












