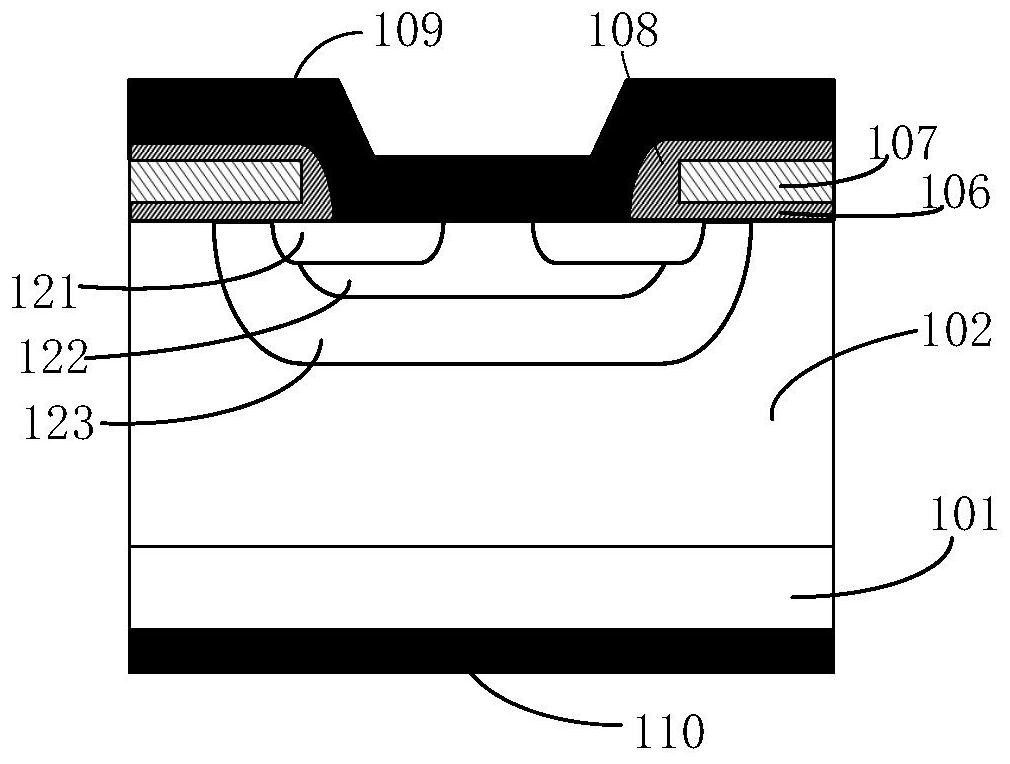
技术摘要:
本发明提供了一种碳化硅MOSFET器件及其制造方法,所述方法包括:提供一具有第一掺杂类型的基底;在所述基底的第一表面形成图案化的第一阻挡层;通过所述第一阻挡层在所述基底中形成具有第一掺杂类型的源区;在所述基底中形成第二掺杂类型的基区和第二掺杂类型的接触区 全部
背景技术:
在SiC MOSFET领域,为了减小元胞尺寸、提高电流密度,将沟道的长度设置的越短 越好,考虑到光刻精度的影响,长度小于0.5um的沟道一般会使用自对准工艺实现。由于SiC 的扩散系数较低,无法使用Si标准的自对准工艺形成沟道,现有的SiC MOSFET沟道自对准 工艺首先利用光刻后的多晶硅做P型基区的阻挡层,形成P型基区后对多晶硅进行氧化,多 晶硅会在表面以及侧壁形成一定厚度的二氧化硅,然后利用侧壁的二氧化硅作为阻挡层可 以实现N 源区的自对准注入。另外,在形成P 接触区时,因为N 源区的离子注入剂量要远大 于P 接触区,因此都需要一张单独的掩膜版来形成P 接触区的阻挡层,增加了制造成本。
技术实现要素:
有鉴于此,本发明的目的在于提供一种碳化硅MOSFET器件及其制造方法,以解决 上述问题。 根据本发明的第一方面,提供一种碳化硅MOSFET器件的制造方法,包括:提供一具 有第一掺杂类型的基底;在所述基底的第一表面形成图案化的第一阻挡层;通过所述第一 阻挡层在所述基底中形成具有第一掺杂类型的源区;在所述基底中形成第二掺杂类型的基 区和第二掺杂类型的接触区,以及形成栅极结构,其中,所述第一阻挡层包括第一部分和第 二部分,所述第一部分包括半导体层和与所述半导体层不同的可去除层,所述第二部分仅 包括所述可去除层。 优选地,根据所述源区的位置,以在所述基底第一表面的相应区域设置第一阻挡 层的所述第一部分和所述第二部分。 优选地,所述第一部分位于所述基底第一表面边缘区域;第二部分位于所述基底 第一表面中间区域。 优选地,所述可去除层为氧化层。 优选地,还包括,在形成所述第一阻挡层之前,采用第一掩膜版在所述基底的第一 表面形成图案化的包括第一部分和第二部分的沉积层。 优选地,所述沉积层的第一部分位于所述基底第一表面边缘区域,所述沉积层的 第二部分位于所述基底第一表面中间区域。 优选地,所述形成图案化的第一阻挡层的方法包括:通过热氧化工艺在所述基底 的第一表面和所述沉积层上形成第一氧化层,以及刻蚀部分所述第一氧化层以形成所述第 一阻挡层,其中,在所述热氧化工艺中,所述沉积层的第一部分被部分氧化成所述第一氧化 层,所述沉积层的第二部分被完全氧化为所述第一氧化层,所述基底的第一表面保留的沉 积层为所述半导体层,所述第一氧化层为所述可去除层。 4 CN 111554746 A 说 明 书 2/6 页 优选地,通过控制所述沉积层的第二部分的宽度以使得所述沉积层的第二部分被 完全氧化。 优选地,通过控制所述热氧化工艺的温度和时间以使得所述沉积层的第二部分被 完全氧化。 优选地,根据所述器件的沟道的长度设置所述沉积层的第二部分的宽度。 优选地,设置所述沉积层的第二部分的宽度不大于所述器件的沟道的长度。 优选地,所述沉积层被设置为多晶硅或非晶硅。 优选地,设置所述沉积层第一部分被氧化成的所述第一氧化层的宽度等于所述器 件的沟道的长度。 优选地,还包括去除所述第一阻挡层的所述可去除部分。 优选地,形成所述接触区的方法包括:在所述基底的第一表面和所述半导体层上 形成第二氧化层,刻蚀所述第二氧化层形成位于所述半导体层侧壁的侧墙,以及以所述半 导体层和所述侧墙作为第二阻挡层形成所述接触区。 优选地,在形成所述接触区之后,形成所述基区的方法包括:去除所述侧墙,以及 以所述半导体层作为第三阻挡层形成所述基区。 优选地,在形成所述接触区之前,形成所述基区的方法包括以所述第一阻挡层的 所述半导体层部分作为第三阻挡层形成所述基区。 优选地,在形成所述源区之前,形成所述基区的方法包括以所述沉积层作为第三 阻挡层形成所述基区。 优选地,还包括去除所述所述半导体层。 优选地,还包括去除所述所述半导体层和所述侧墙。 优选地,其中,形成所述栅极结构的方法包括:在所述基底的第一表面形成栅氧 层,在所述栅氧层上形成图案化的栅极导体。 优选地,还包括:在所述基底的第一表面和栅极导体上沉积层间介质,刻蚀所述层 间介质和所述栅氧层形成开孔,以裸露部分所述基区和所述源区的第一表面,以及在所述 基底的第一表面和第二表面淀积金属,形成源漏区电极,其中,所述基底的第一表面和第二 表面相对。 优选地,所述第二氧化层通过气相沉积的工艺形成。 优选地,所述第一掺杂类型为N型和P型之一,所述第二掺杂类型为N型和P型中另 一个。 根据本发明的第二方面,提供一种根据所述的方法形成的碳化硅MOSFET器件,包 括:基底,从所述基底的第一表面延伸至其内的基区,接触区和源区,位于所述基底第一表 面的栅极结构,所述栅极结构至少部分覆盖所述源区和所述基区,位于所述栅极结构侧壁 和上表面的层间介质,其中,所述基底,所述源区为第一掺杂类型,所述基区和所述接触区 为第二掺杂类型。 根据本发明提供的制造碳化硅MOSFET的方法,通过在基底第一表面形成一层图案 化的沉积层,所述图案化的沉积层包括位于基底第一表面的边缘区域的第一部分以及位于 所述基底第一表面中间区域的二部分;并通过热氧化工艺将所述第一部分部分氧化以及将 第二部分完全氧化形成二氧化硅以作为形成源区的阻挡层。使得在后续去除二氧化硅的步 5 CN 111554746 A 说 明 书 3/6 页 骤中,所述基底第一表面中间区域的氧化层可以被完全去除,然后实现接触区的自对准注 入。无需再单独形成一张实现接触区自对准注入的掩膜版,节约了制造成本。 附图说明 通过以下参照附图对本发明实施例的描述,本发明的上述以及其他目的、特征和 优点将更为清楚,在附图中: 图1A-1J示出根据本发明的第一实施例的制造碳化硅MOSFET的方法的各个阶段的 截面图; 图2A-2C示出根据本发明的第二实施例的制造碳化硅MOSFET的方法的某些步骤的 截面图。












