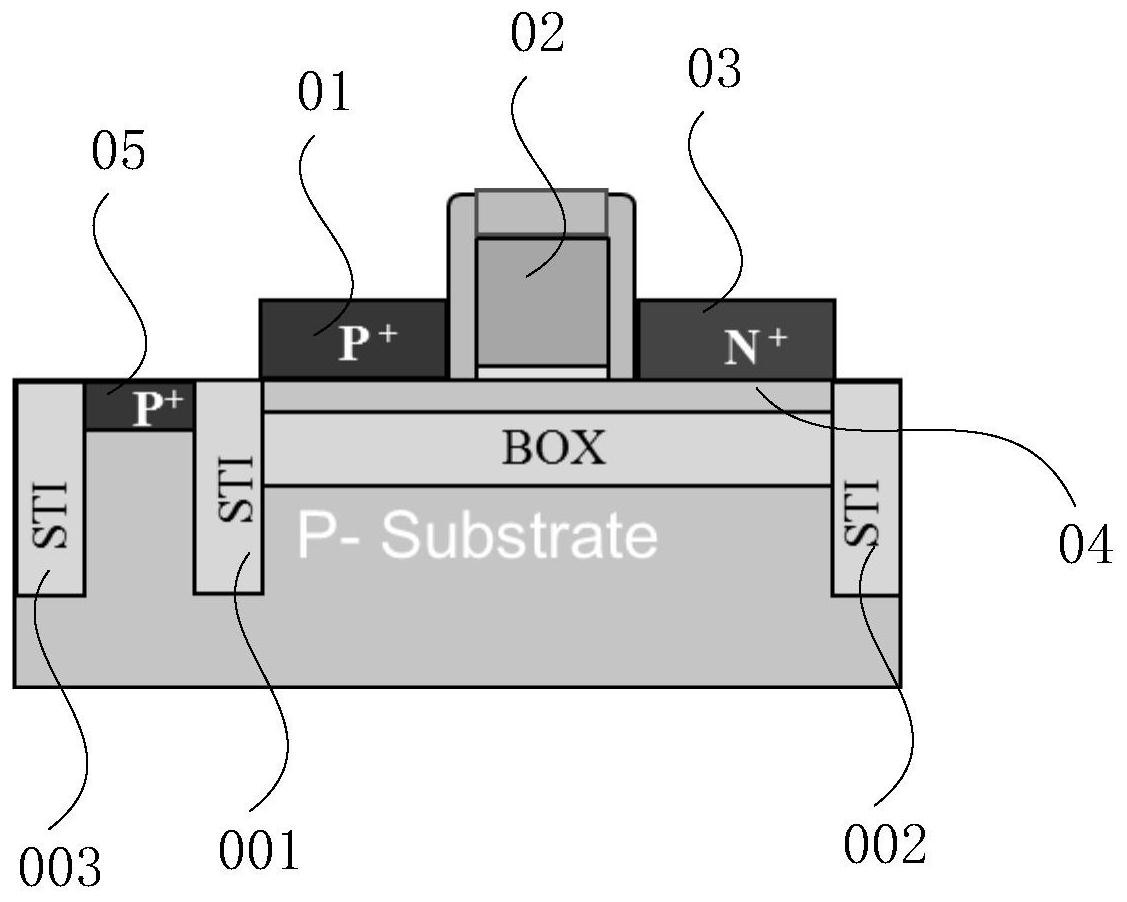
技术摘要:
本发明提供一种基于FDSOI的PIN结构及其制作方法,位于P型衬底浅区域的埋氧层;埋氧层上方P型衬底的区域为沟道区;位于沟道区上的栅极结构;分别位于栅极结构两侧的第一P 区和N 区;从沟道区表面经过埋氧层边缘并延伸至P型衬底深处的第一、第二STI区,第一STI区位于第一 全部
背景技术:
电荷泵(Charge pumping)在体硅工艺中,常用来提取界面态,并且可以将界面的 能级分布提取出来。但是对FDSOI器件,沟道是无掺杂的,且沟道与衬底之间被埋氧层(BOX) 隔离。因此沟道反型时的载流子只能来源于源漏,且无法形成积累区。因此,常规NFET/PFET 结构无法通过charge pumping来对界面态及其能态分布进行提取和评估。 因此,需要提出一种新的PIN结构及其制作方法来解决上述问题。
技术实现要素:
鉴于以上所述现有技术的缺点,本发明的目的在于提供一种基于FDSOI的PIN结 构,用于解决现有技术中由于常规NFET/PFET无法通过电荷泵来对界面态及其能态分布进 行提取和评估的问题。 为实现上述目的及其他相关目的,本发明提供一种基于FDSOI的PIN结构,至少包 括,P型衬底、位于所述P型衬底浅区域的埋氧层;所述埋氧层上方所述P型衬底的区域为沟 道区;位于所述沟道区上的栅极结构;分别位于所述栅极结构两侧的第一P 区和N 区;从所 述沟道区表面经过所述埋氧层边缘并延伸至所述P型衬底深处的第一、第二STI区,所述第 一STI区位于所述第一P 区远离所述栅极一侧的边缘;所述第二STI区位于所述N 远离所述 栅极一侧的边缘。 优选地,所述栅极结构包括位于所述沟道区上的氧化层;位于所述氧化层上的多 晶硅结构;所述氧化层和所述多晶硅结构的侧壁以及所述多晶硅结构的顶部覆盖有侧墙。 优选地,所述PIN结构还包括:从所述P型衬底表面延伸至所述P型衬底深处且与所 述第一STI区相互间隔的第三STI区,所述第三STI区位于所述第一STI区远离所述第二STI 区的一侧,所述第一STI区与所述第三STI区之间的所述P型衬底的表面区域设有第二P 区。 本发明还提供一种基于FDSOI的PIN结构的制作方法,该方法至少包括以下步骤: 步骤一、提供P型衬底,在所述P型衬底上形成第一、第二STI区; 步骤二、在所述第一、第二STI区之间的所述P型衬底的浅区域形成埋氧层;所述埋 氧层上方的所述P型衬底的区域为沟道区; 步骤三、在所述沟道区上形成栅极结构; 步骤四、在所述栅极结构两侧的所述沟道区上分别形成第一P 区和N 区;所述第 一P 区位于所述第一STI区与所述栅极结构之间的所述沟道区上并且所述第一P 区远离所 述栅极结构的边缘沿所述第一STI区的边缘;所述N 区位于所述第二STI区与所述栅极结构 之间的所述沟道区上并且所述N 区远离所述栅极结构的边缘沿所述第二STI区的边缘。 优选地,步骤一中在所述P型衬底上形成所述第一、第二STI区的同时,在所述第一 4 CN 111584637 A 说 明 书 2/5 页 STI区远离所述第二STI区的一侧的所述P型衬底上形成第三STI区,所述第三STI区与所述 第一STI区相互间隔。 优选地,步骤四在所述栅极结构两侧的所述沟道区上分别形成第一P 区和所述N 区的同时,在所述第三STI区与所述第一STI区之间的所述P型衬底表面区域形成第二P 区。 优选地,步骤四中形成所述第一P 区以及N 区的方法至少包括:(1)悬涂光刻胶; (2)利用用于形成所述第一P 区以及N 区的光罩进行曝光,曝光时将所述光罩上用于形成 所述第一P 区和用于形成所述N 区的掩膜图形的交界处正投影于所述栅极结构上;(3)曝 光后进行显影,形成位于所述第一STI区与所述栅极结构之间的第一光刻胶图形和位于所 述第二STI区与所述栅极结构之间的第二光刻胶图形;(4)按照所述第一光刻胶图形进行P 型重掺杂形成所述第一P 区;按照所述第二光刻胶图形进行N型重掺杂形成所述N 区。 优选地,步骤四中形成所述第一P 区以及N 区的方法至少包括:(a)悬涂光刻胶; (b)利用用于形成所述第一P 区、第二P 区以及N 区的光罩进行曝光,曝光时将所述光罩上 用于形成所述第一P 区和用于形成所述N 区的掩膜图形的交界处正投影于所述栅极结构 上;将用于形成所述第二P 区的掩膜图形正投影于所述第一、第三STI区之间的区域;(c)曝 光后进行显影,形成位于所述第一STI区与所述栅极结构之间的第一光刻胶图形;形成位于 所述第二STI区与所述栅极结构之间的第二光刻胶图形,以及形成位于所述第一、第三STI 区之间的第三光刻胶图形;(d)按照所述第一光刻胶图形进行P型重掺杂形成所述第一P 区;按照所述第二光刻胶图形进行N型重掺杂形成所述N 区;按照所述第三光刻胶图形进行 P型重掺杂形成所述第二P 区。 优选地,步骤(2)中用于形成所述第一P 区和用于形成所述N 区的掩膜图形的交 界处正投影于所述栅极结构上的中央位置。 优选地,步骤(b)中用于形成所述第一P 区和用于形成所述N 区的掩膜图形的交 界处正投影于所述栅极结构上的中央位置。 优选地,步骤三中形成所述栅极结构的方法包括:(01)在所述沟道区上形成一层 氧化层;(02)在所述氧化层上形成一层多晶硅;(03)刻蚀所述多晶硅和所述氧化层,形成栅 极;(04)在所述栅极的顶部和侧壁覆盖一层侧墙形成所述栅极结构。 如上所述,本发明的基于FDSOI的PIN结构及其制作方法,具有以下有益效果:本发 明通过将传统PIN结构中栅极一侧的N 区替换为P 区,可以有效提取沟道区与栅极之间的 界面态以及能带分布,克服了常规NFET或PFET无法通过电荷泵来对界面态即能态分布进行 提取的缺陷;同时利用制作栅极两侧的P 区和N 区的光罩,将二者交界处置于栅极上方,利 用栅极多晶硅或其侧墙作为N型重掺杂和P型重掺杂注入的阻挡层,可以将光刻的工艺窗口 增大。 附图说明 图1显示为本发明的PIN结构的剖面结构示意图; 图2显示为本发明的PIN结构的俯视结构示意图; 图3显示为本发明的PIN结构的四端口结构的剖面示意图。 5 CN 111584637 A 说 明 书 3/5 页












