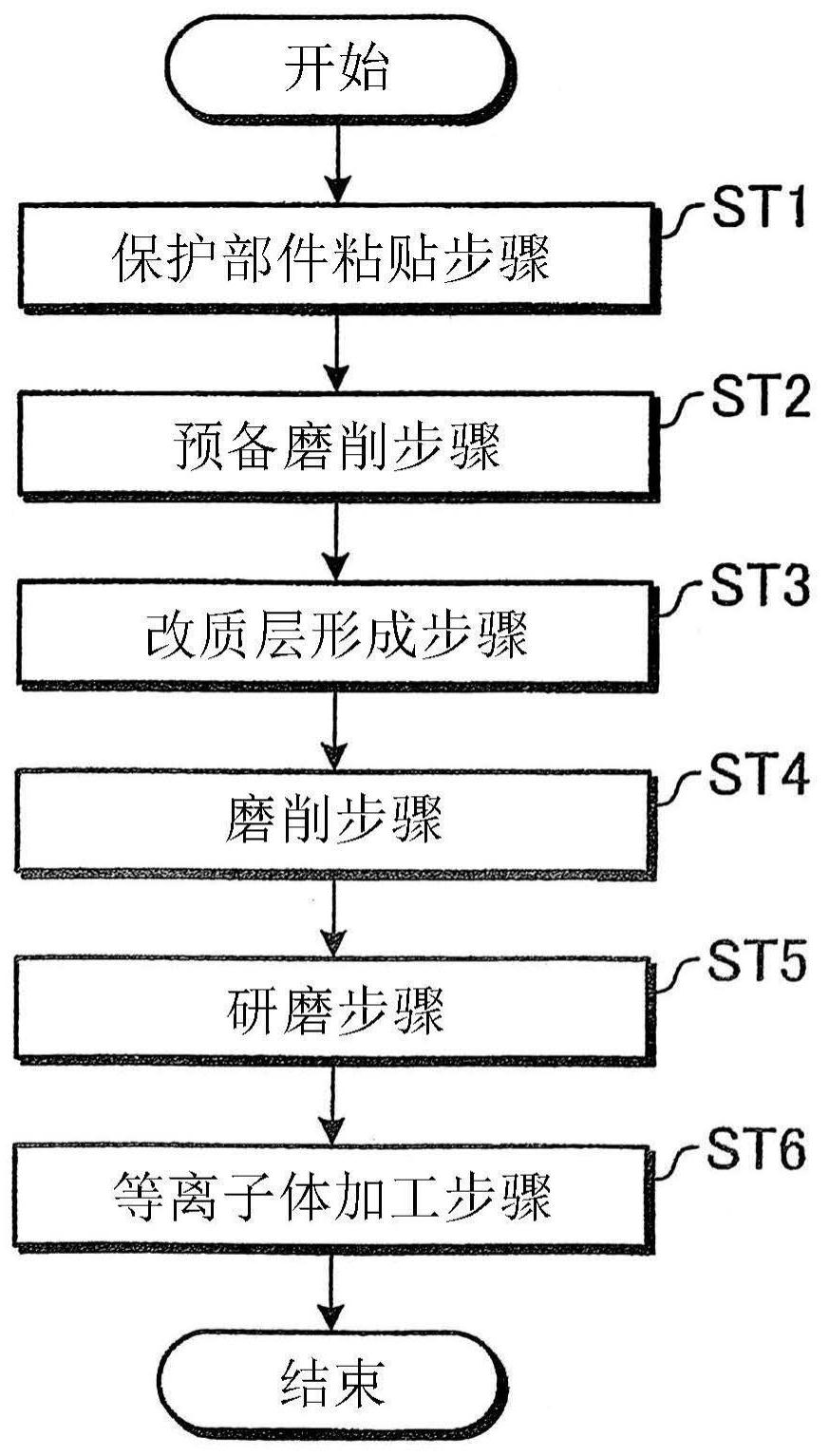
技术摘要:
提供晶片的加工方法,能够提高器件芯片的抗弯强度。晶片的加工方法具有如下的步骤:保护部件粘贴步骤,在晶片的正面侧粘贴保护带;磨削步骤,隔着保护带将晶片保持在卡盘工作台上,对晶片的背面侧进行磨削而薄化至规定的厚度;研磨步骤,利用研磨垫对通过磨削步骤进行 全部
背景技术:
器件芯片正在不断薄化、小型化,但始终要求提高抗弯强度。在对半导体器件晶片 进行薄化时,由磨削磨具形成的破碎层会使抗弯强度降低,因此实施通过研磨将破碎层去 除而提高抗弯强度的方法。但是,当将破碎层去除时,会失去芯片的去疵效果,在存储器器 件等中成为器件不良的原因。因此,提出了所谓去疵干式抛光的方法(例如,参照专利文献 1)。 专利文献1所示的方法是利用包含磨粒的研磨垫进行干式研磨的方法,在通过研 磨将破碎层去除的同时形成可发挥去疵效果的程度的小的伤痕。 专利文献1:日本特许第4871617号公报 但是,希望进一步提高器件芯片的抗弯强度。
技术实现要素:
因此,本发明的目的在于,提供能够提高器件芯片的抗弯强度的晶片的加工方法。 根据本发明,提供晶片的加工方法,该晶片在半导体基板的正面上形成有格子状 的多条分割预定线,在由该分割预定线划分的各区域中形成有器件,其中,该晶片的加工方 法具有如下的步骤:保护部件粘贴步骤,在晶片的正面侧粘贴保护部件;磨削步骤,隔着该 保护部件将晶片保持在卡盘工作台上,对晶片的背面侧进行磨削而薄化至规定的厚度;研 磨步骤,利用研磨垫对通过该磨削步骤进行了磨削的晶片的背面侧进行研磨,将通过该磨 削步骤而形成的破碎层去除;以及等离子体加工步骤,向通过该研磨步骤进行了研磨的晶 片的背面侧提供处于等离子体状态的惰性气体,将晶片的背面侧的表层去除。 优选在该研磨步骤中,使用包含磨粒的该研磨垫对晶片的背面侧进行研磨,将通 过该磨削步骤而形成的破碎层去除并且利用该磨粒形成作为去疵层的微细的加工应变。 优选在该等离子体加工步骤中,在晶片的背面侧的表层形成由无定形层构成的预 备去疵层。 优选所述晶片的加工方法还具有如下的改质层形成步骤:在实施该磨削步骤之 前,沿着该分割预定线照射对于该半导体基板具有透过性的波长的激光光线,在晶片的内 部形成沿着该分割预定线的改质层,通过因该磨削步骤而产生的磨削应力,晶片以该改质 层为断裂起点而被分割。 优选所述晶片的加工方法还具有如下的切削步骤:在实施该磨削步骤之前,从晶 片的正面侧沿着该分割预定线利用切削刀具形成深度超过完工厚度的切削槽,在该磨削步 骤中,该切削槽在晶片的背面侧露出而将晶片分割。 本申请发明的晶片的加工方法起到能够提高器件芯片的抗弯强度这一效果。 3 CN 111584352 A 说 明 书 2/10 页 附图说明 图1是示出第1实施方式的晶片的加工方法的加工对象的晶片的一例的立体图。 图2是示出第1实施方式的晶片的加工方法的流程的流程图。 图3是示出图2所示的晶片的加工方法的保护部件粘贴步骤的立体图。 图4是图2所示的晶片的加工方法的保护部件粘贴步骤后的晶片的立体图。 图5是示出图2所示的晶片的加工方法的预备磨削步骤的侧剖视图。 图6是示出图2所示的晶片的加工方法的改质层形成步骤的侧剖视图。 图7是示出实施图2所示的晶片的加工方法的磨削步骤和研磨步骤的磨削研磨装 置的结构例的立体图。 图8是示出图2所示的晶片的加工方法的磨削步骤的侧剖视图。 图9是示出图2所示的晶片的加工方法的研磨步骤的侧剖视图。 图10是将图2所示的晶片的加工方法的研磨步骤后的晶片的主要部分放大而示出 的剖视图。 图11是示出在图2所示的晶片的加工方法的等离子体加工步骤中使用的等离子体 装置的结构的剖视图。 图12是将图2所示的晶片的加工方法的等离子体加工步骤中的晶片的主要部分放 大而示出的剖视图。 图13是将图2所示的晶片的加工方法的等离子体加工步骤后的晶片的主要部分放 大而示出的剖视图。 图14是示出第2实施方式的晶片的加工方法的流程的流程图。 图15是示出图14所示的晶片的加工方法的切削步骤的侧剖视图。 标号说明 1:晶片;2:半导体基板;3:正面;4:分割预定线;5:器件;6:器件芯片;7:背面;8:改 质层;9:切削槽;10:去疵层;11:加工应变;12:预备去疵层;12-1:无定形层;20:保护带(保 护部件);44:激光光线;54-1:研磨垫;56:卡盘工作台;100:完工厚度;400:处于等离子体状 态的惰性气体;ST1:保护部件粘贴步骤;ST3:改质层形成步骤;ST4:磨削步骤;ST5:研磨步 骤;ST6:等离子体加工步骤;ST10:切削步骤。












