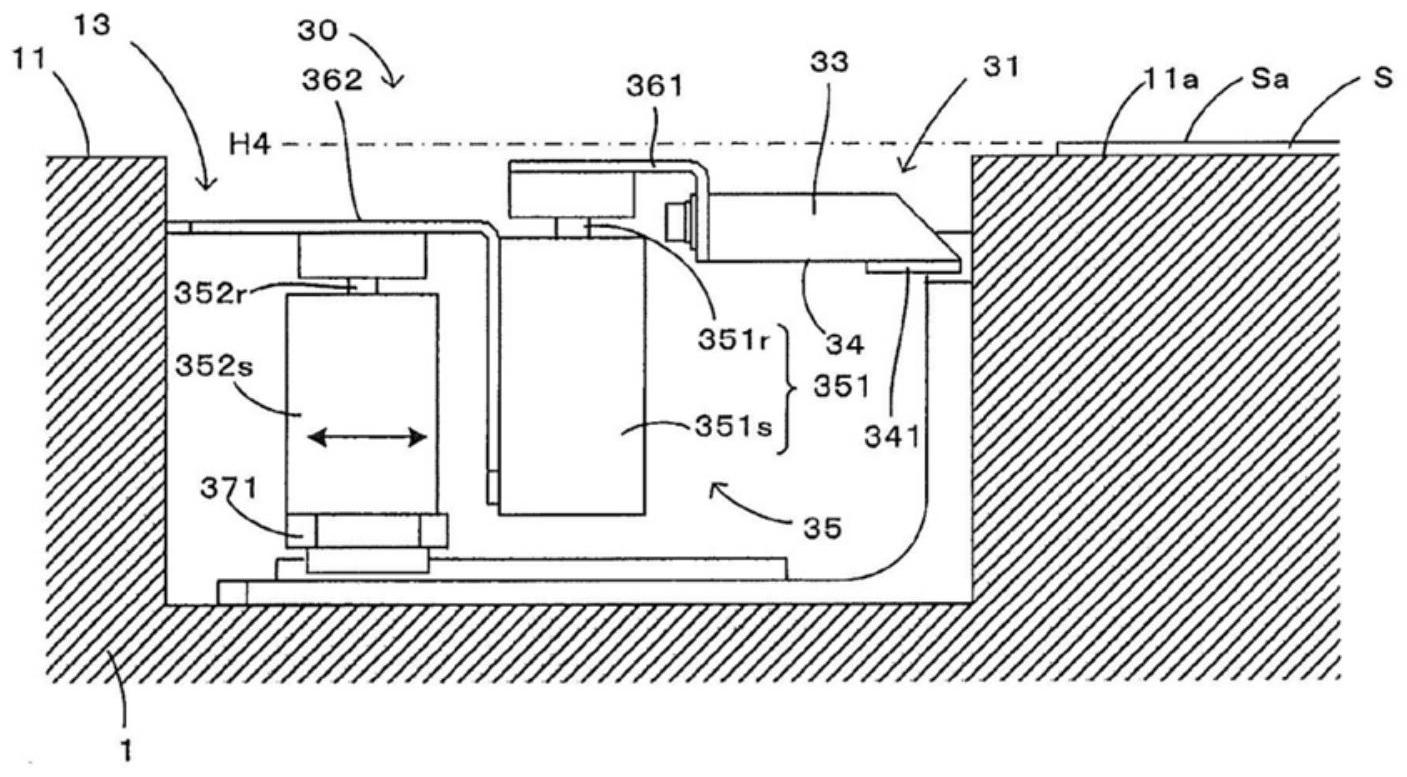
技术摘要:
本发明提供一种基板处理装置及基板处理方法。本发明的课题在于确实地防止矫正构件与检测部发生干扰,所述矫正构件对载置于平台的基板进行矫正,所述检测部一边在沿着平台的上表面的第一方向上移动一边对已矫正的基板的上表面的表面状态进行检测。包括退避部,所述退避 全部
背景技术:
以前,作为基板处理装置的一例,已知有对基板进行涂布液的涂布等处理的涂布 装置(例如,参照专利文献1)。所述涂布装置包括:基板保持装置,吸附并保持载置于平台的 上表面的基板的下表面;以及狭缝喷嘴,在与由基板保持装置保持的基板的上表面近接的 状态下,相对于所述基板沿水平方向相对移动,由此将涂布液涂布于基板的上表面。 在所述基板保持装置中,为了抑制在基板的周边部附近产生的翘曲的影响,在平 台的周围配置有按压构件(相当于本发明的“矫正构件”的一例)。而且,在基板的翘曲大的 情况下,按压构件对基板的上表面的周边部自上方进行按压来矫正基板的翘曲。因此,可将 基板的整个区域吸附保持于平台上,从而可良好地进行涂布处理等基板处理。 [现有技术文献] [专利文献] [专利文献1]日本专利特开2017-112197号公报 [专利文献2]日本专利特开2006-167610号公报 [专利文献3]日本专利特开2005-85773号公报
技术实现要素:
[发明所要解决的问题] 然而,在涂布装置中,在成为狭缝喷嘴的下端部的喷出口与基板近接的状态下,狭 缝喷嘴相对于基板移动。因此,若异物附着于基板的上表面或因基板与保持基板的保持面 之间的异物而在基板存在隆起部,则存在如下担忧:这些异物或隆起部与狭缝喷嘴接触而 产生狭缝喷嘴的损伤、基板的损伤或者涂布不良等。因此,提出有如下技术:在异物等与狭 缝喷嘴接触前,一边使检测部沿着基板的上表面移动,一边对基板的上表面的表面状态进 行检测,基于所述检测结果而在异物等与狭缝喷嘴接触前停止狭缝喷嘴的相对移动(参照 专利文献2、专利文献3)。因此,提出了将所述技术应用于所述专利文献1中所记载的基板处 理装置。 然而,若将专利文献2或专利文献3中所记载的检测技术应用于具备矫正基板的翘 曲的按压构件的基板处理装置,则存在用以进行异物检测的挡板构件(参照专利文献2)或 检测传感器(参照专利文献3)与按压构件发生干扰的情况,所述情况成为给涂布处理等基 3 CN 111584391 A 说 明 书 2/12 页 板处理带来阻碍的主要原因之一。 本发明是鉴于所述课题而完成的,其目的在于提供一种可确实地防止矫正构件与 检测部发生干扰的基板处理装置及基板处理方法,所述矫正构件对载置于平台的基板进行 矫正,所述检测部一边在沿着平台的上表面的第一方向上移动一边对已矫正的基板的上表 面的表面状态进行检测。 [解决问题的技术手段] 本发明的一实施方式为一种基板处理装置,包括:平台,在上表面设置供基板载置 的载置区域,对载置于载置区域的基板进行保持;移动体,在沿着平台的上表面的第一方向 上移动;检测部,一边与移动体朝向第一方向的移动同时沿第一方向移动,一边对保持于平 台的基板的上表面的表面状态进行检测;矫正构件,在利用平台保持基板前,位于载置于载 置区域的基板的上表面周边部的上方位置并将上表面周边部按压至平台侧来进行矫正;以 及退避部,在将通过矫正构件而受到矫正后的基板保持于平台后且开始检测部的移动前, 使矫正构件退避至较保持于平台的基板的上表面的高度位置低的位置。 另外,本发明的另一实施方式为一种基板处理方法,包括:使矫正构件移动至基板 的上表面周边部的上方位置,所述基板载置于载置区域,所述载置区域设置于平台的上表 面,并将上表面周边部按压至平台侧来进行矫正的工序;利用平台来保持通过矫正构件而 受到矫正后的基板的工序;使矫正构件自保持于平台的基板的上方退避至较基板的上表面 的高度位置低的位置的工序;以及在矫正构件位于较高度位置低的位置的期间,使移动体 沿平台的第一方向移动,并且使检测部沿第一方向移动,同时对保持于平台的基板的上表 面的表面状态进行检测的工序。 在以所述方式构成的发明中,检测部一边沿第一方向移动一边对保持于平台的基 板的上表面的表面状态进行检测。另外,矫正构件位于载置于平台的载置区域的基板的上 表面周边部的上方位置并进行基板的矫正。如此,若检测部及矫正构件位于基板的上方的 期间全部或部分重叠,则两者会发生干扰。因此,在本发明中,进行矫正处理的矫正构件自 保持于平台的基板的上方退避至较基板的上表面的高度位置低的位置,在所述退避状态 下,一边与移动体的移动同时使检测部沿第一方向移动,一边对保持于平台的基板的上表 面的表面状态进行检测。再者,所谓“与移动体的移动同时使检测部沿第一方向移动”是指 使检测部与移动体一体地或独立于移动体地移动。 [发明的效果] 如上所述,根据本发明,在矫正构件自保持于平台的基板的上方退避至较基板的 上表面的高度位置低的位置的状态下,检测部移动来对基板的上表面的表面状态进行检 测,因此可确实地防止矫正构件与检测部的干扰。 附图说明 图1是表示作为本发明的基板处理装置的第一实施方式的涂布装置的立体图。 图2是图1所示的涂布装置的部分平面图。 图3是表示图1所示的涂布装置的电气构成的框图。 图4是表示第一实施方式中的矫正机构的矫正块与用以使所述矫正块移动的移动 部的立体图。 4 CN 111584391 A 说 明 书 3/12 页 图5A是示意性表示第一实施方式中的矫正块利用移动部而进行的移动的侧视图。 图5B是示意性表示第一实施方式中的矫正块利用移动部而进行的移动的侧视图。 图6是表示本发明的基板处理装置的第二实施方式的电气构成的框图。 图7是表示第二实施方式中的矫正机构的矫正块与用以使所述矫正块移动的移动 部的立体图。 图8A是示意性表示第二实施方式中的矫正块利用移动部而进行的移动的侧视图。 图8B是示意性表示第二实施方式中的矫正块利用移动部而进行的移动的侧视图。 图9是表示与矫正块连结,并在矫正块与基板之间强制形成空气层的空气层形成 部的构成的图。 图10是表示第二实施方式中的基板固定的一例的流程图。 图11是示意性地表示根据图10的流程图而执行动作的动作说明图。 图12是表示本发明的基板处理装置的第二实施方式所配备的空气层形成部的另 一构成的图。 [符号说明] 1:平台 2:位置调整机构 3:矫正机构 4:狭缝喷嘴 5:移动机构 6:第一检测部 7:第二检测部 10:控制器 11:(平台的)上表面 11a:载置区域 11b:侧端面 12:顶销 13:凹坑(凹部) 20:位置调整单元 21:定位销 30:矫正单元 31:矫正块 32、115:切口部 33:框架 34:相向平板 35:移动部(退避部) 38:空气层形成部 39:空气层 51:喷嘴支撑体(移动体) 51a:梁构件 5 CN 111584391 A 说 明 书 4/12 页 51b:柱构件 52:喷嘴移动部 53:导轨 54:线性马达 54a:定子 54b:动子 55:位置传感器 55a:刻度部 55b:检测部 61:挡板构件 71、72:检测传感器 73:传感器光 100:涂布装置 112:空气供给部 113:空气抽吸部 114:销收纳孔 341:接触构件 342:贯通孔 343:抽吸孔 351、352:垂直致动器 351r、352r:杆 351s、352s:筒体部 353:水平致动器 361、362:托架 371:移动板 372:轨道 373:基座构件 381:压缩部 382:温度调节部 383:过滤器 384:针阀 385:流量计 386:压力计 387:气动阀 388:抽吸系统 388a:鼓风机 388b:压力计 388c:调压阀 A21:位置调整致动器 6 CN 111584391 A 说 明 书 5/12 页 A112:顶销致动器 H1、H2、H3、H4:高度位置 S:基板 Sa:(基板的)上表面 S101、S102、S103、S104、S105、S106、S107、S108、S109、S110、S111、S112:步骤 X:第一方向 Y:水平方向 Z:铅垂方向












