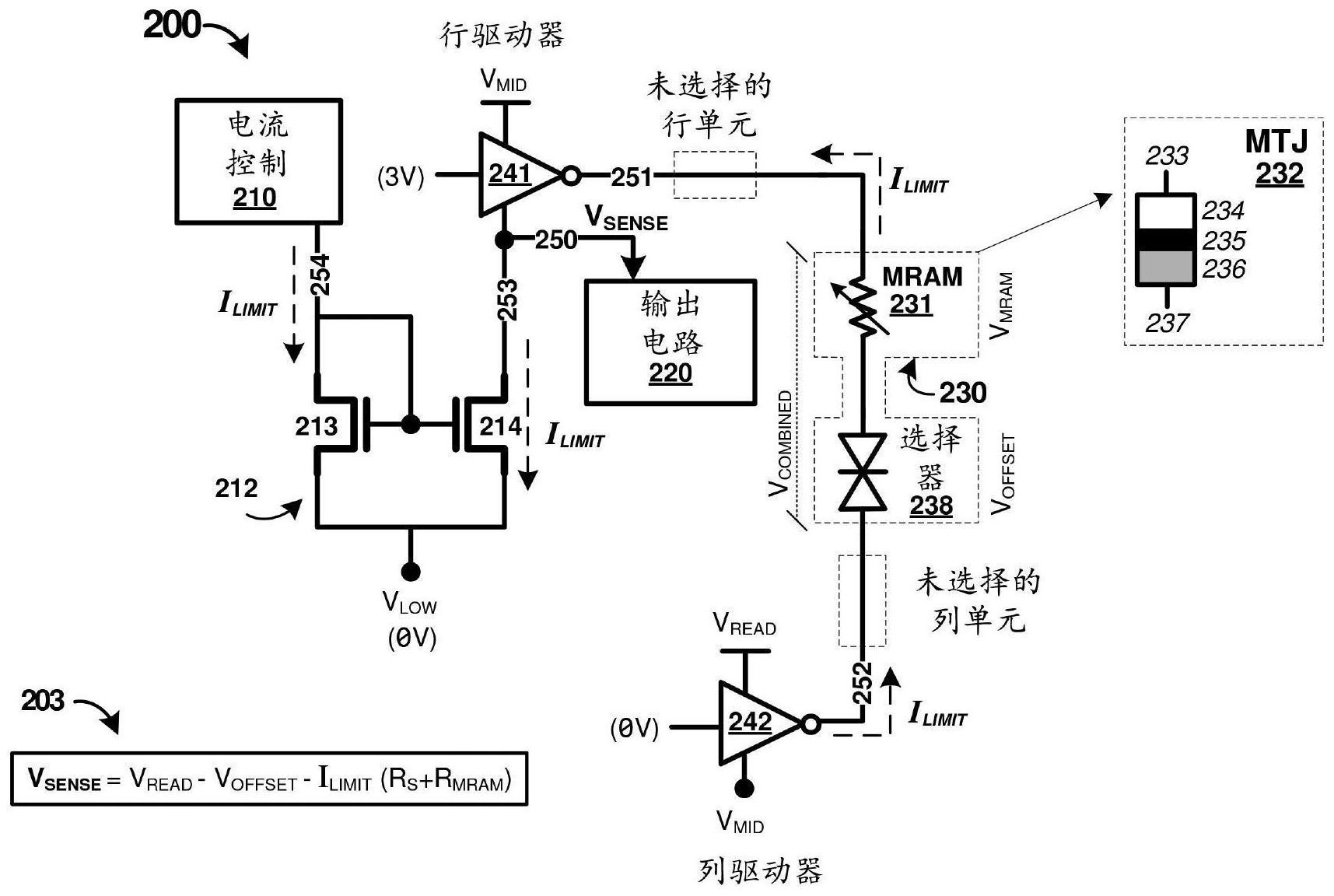
技术摘要:
本发明题为“具有选择器电压补偿的磁性随机存取存储器。”本文提供了磁性随机存取存储器(MRAM)电路。在一个示例性具体实施中,MRAM电路包括耦合到与选择器元件串联的磁性隧道结(MTJ)元件的控制电路。所述控制电路被配置为当所述选择器元件处于导电状态下时调节通过所述 全部
背景技术:
磁性随机存取存储器(MRAM)是一种新兴的存储器/存储技术,其具有为随机存取 存储器(RAM)技术(如静态RAM(SRAM)和动态RAM(DRAM))提供低功率和非易失性替代方案的 潜力。MRAM还可用于大容量存储环境中,诸如固态存储驱动器(SSD)中。然而,已证明MRAM难 以结合到DRAM竞争器件中。DRAM器件通常具有超过大多数其他竞争存储器技术的密度和每 位成本。 多种方法可用于基于MRAM的存储器。一种此类方法包括交叉点配置,该交叉点配 置也可应用于电阻RAM技术中。在交叉点配置中,存储器单元被布置为经由行和列耦合的大 阵列,在行和列的每个结处为存储器单元。然而,使用这些新兴的存储器技术(如MRAM),交 叉点配置可能难以形成高密度配置。当存储器单元被单独地布置为具有在编程操作期间隔 离每个单元的选择电路时,可出现困难。一些MRAM具体实施具有耦合到每个存储器单元的 三端子晶体管,这显著増加了相关联的部件计数,同时降低了MRAM器件的目标密度。 概述 本文提供了磁性随机存取存储器(MRAM)电路。在一个示例性具体实施中,MRAM电 路包括耦合到与选择器元件串联的磁性隧道结(MTJ)元件的控制电路。该控制电路被配置 为当选择器元件处于导电状态下时调节通过所述选择器元件的电流。该电路还包括补偿电 路,该补偿电路被配置为基于对通过选择器元件的电流的调节来补偿处于导电状态下的选 择器元件上的偏置电压。输出电路也被配置为报告MTJ元件的磁化状态。 附图说明 参考以下附图可以更好地理解本公开的许多方面。尽管结合这些附图描述了几种 具体实施,但本公开并不限于本文所公开的具体实施。相反,其旨在涵盖所有另选方案、修 改和等同物。 图1示出了具体实施中的存储器阵列和相关联的电路。 图2示出了具体实施中的存储器单元。 图3示出了具体实施中的存储器单元的示例控制和输出电路。 图4示出了具体实施中的存储器单元的示例控制和输出电路。 图5示出了具体实施中的存储器单元的示例信令和性能。 图6示出了具体实施中的存储器单元的示例控制和输出电路。 图7示出了具体实施中的存储器单元的示例信令和性能。 图8示出了具体实施中的存储器单元的示例操作。 图9示出了具体实施中的选择器元件的示例特征。 6 CN 111599393 A 说 明 书 2/11 页
技术实现要素:
出现了可替代常规基于晶体管的存储器和存储器件的若干记忆存储技术。这些记 忆存储技术包括电阻随机存取存储器(RRAM)、相变存储器(PCM),以及磁性随机存取存储器 (MRAM)以及其他存储器。其中,MRAM有潜力提供嵌入式SRAM的更低功率替代方案,并提供独 立DRAM的高性价比、非易失性替换。为了与DRAM竞争或替换DRAM,必须将MRAM形成为足够致 密的阵列。由于DRAM的低成本和高密度,这可能是具有挑战性的,并且必须使MRAM表现出 DRAM的低误差水平。交叉点阵列是一种实现MRAM的致密阵列的方法。MRAM单元通常具有表 示二进制位的两种存储状态,其中每种状态具有基本上线性的电流-电压关系。因此,分立 或独立的选择器件通常用于将阵列中的MRAM单元彼此电隔离。这些选择器件可包括三端子 晶体管选择器,诸如负/正金属氧化物半导体晶体管。然而,由于选择器的尺寸很大以及需 要将栅极控制线路由到每个存储器单元,因此每个存储器单元包括晶体管选择器可大大増 加单元尺寸并降低MRAM阵列的密度。另外,由于具有前述两种MRAM状态的单元电阻通常在 电阻值方面仅相差2-3倍,因此采用的任何选择器应具有非线性特性。该非线性特性将对应 于低电压下的高电阻和高电压下的低电阻。另外,期望的选择器也可具有阈值切换特性,其 中一旦满足阈值切换条件(诸如阈值电压),则选择器就以一定程度的滞后保持处于所选择 的状态下。 如本文所讨论的,MRAM单元包括非易失性存储器(NVM)元件,该NVM元件可由将数 据存储为一种或多种磁性状态的一个或多个磁性元件形成。MTJ器件通常采用自旋偏振电 流以可逆地切换铁磁层的磁化状态。MTJ使用隧道磁电阻(TMR)操作,TMR是磁阻效应。MTJ通 常由两层铁磁材料组成,该两层铁磁材料由薄绝缘体层隔开,电子可通过薄绝缘体层以量 子力学方式从一个铁磁性层穿隧进入另一个铁磁性层。MTJ的一个铁磁性层可被称为固定 层(pinned layer),该固定层具有固定磁化状态,而MTJ的另一个铁磁性层包括可在磁化状 态方面变化的自由层。包括分隔两个铁磁性层的薄绝缘体的中间层可由氧化物材料或其他 合适的电绝缘体形成。可以形成电端子,以将MTJ的自由层和固定层与电路中的其他部件进 行交接。 MTJ元件的垂直或平行布置可用于MRAM单元中,该MTJ元件的垂直或平行布置是指 一种类型的磁各向异性,该种类型的磁各向异性与MTJ元件内的磁矩相对于相应半导体基 板的表面的优选对准方向相关联。第一类型的MTJ配置包括均匀的垂直自旋转移矩(STT)布 置,该均匀的垂直STT布置通常包括由至少三个堆叠的材料层形成的2端子器件。这三个层 包括设置在固定层与自由层之间的隧道势垒层。自由层和固定层耦合到STT MTJ的两个端 子。其他类型的MTJ包括自旋轨道扭矩(SOT)MTJ元件,该SOT MTJ元件可用于三端子自旋霍 尔效应(SHE)MRAM单元中。 MTJ元件,诸如上述STT MTJ元件,通常可被放置成处于两种不同的状态下,该两种 不同的状态可对应于存储在所述MTJ元件中的不同逻辑值或数据值。这些状态取决于MTJ元 件的磁化状态,该磁化状态对应于由MTJ元件当前表现出的磁阻值。本文所讨论的MTJ元件 的可改变的磁化状态可在两种状态,即并行状态和反并行状态之间改变。当MTJ元件的自由 层和固定层处于相同的磁化状态时,发生并行状态。当MTJ元件的自由层和固定层处于不同 的磁化状态时,发生反并行状态。可将数据值指派给磁化状态,诸如逻辑‘0’用于反并行状 态和逻辑‘1’用于并行状态,以及其他配置。 7 CN 111599393 A 说 明 书 3/11 页 现在转到用于实现采用MTJ元件的MRAM器件的増强结构,呈现了图1。图1是示出包 括存储器阵列100和各种外围电路的存储器系统110的系统图。该外围电路包括各种控件、 接口和感测电路。在图1中,系统100还包括行解码器电路120、列解码器电路130、感测电路 140、输出电路150和缓冲电路160。图1中示出了各种通信链路和信号线,但这些线路的具体 实施方式可以是变化的。通常,将在存储器阵列110中采用行信号线和列信号线以形成交叉 点存储器布置。该交叉点存储器布置包括位于行和列的每个结处的存储器单元。因此,存储 器阵列110可包括行数量‘m’和列数量‘n’,从而创建各自对应于单个存储器单元的结的‘m’ 乘‘n’阵列。尽管在图1中讨论了MRAM类型的存储器单元,但在交叉点存储器布置中可采用 其他存储器技术。 图1还包括示例存储单元详细视图101。详细视图101示出了存储器阵列110的一部 分的部件级视图,但为了清楚起见,该视图被简化。通常,使用在半导体晶片加工和微加工 中存在的技术(诸如光刻、扩散、沉积、外延生长、蚀刻、退火和离子注入等),将详细视图101 的相关联的部件形成到半导体基板上。详细视图101包括行线114和列线115。可选的MRAM单 元111定位在行线114与列线115之间的物理结点处。可选的MRAM单元111包括MTJ元件112和 选择器元件113。下文讨论关于这些元件的更多细节。详细视图101被提供为交叉点存储器 中的存储器单元的示例配置。交叉点存储器(诸如存储器阵列110)中的行和列的每个结可 包括类似的MRAM单元布置,如详细视图101中所示。此外,在具体实施存储器阵列110期间, 可包括各种互连、金属化、绝缘体、端子和其他元件。 行解码器120和列解码器130通常将耦合至控制电路,该控制电路被配置为控制读 取、写入和擦除操作以及其他操作。行解码器120和列解码器130各自包括线选择电路和逻 辑以按照控制电路的指示启用/禁用存储器阵列110的特定行和列。线选择电路可包括选择 晶体管、缓冲器、反相器、电流和电压限制器电路、传输门,以及其他类似电路。这样,存储器 阵列110中的存储器单元可被读取、写入或擦除。 在读取操作期间,感测电路140感测所选择的存储器单元的输出。感测电路140可 包括感测放大器、比较器、电平位移器,以及各种其他支持电路。感测电路140向输出电路 150提供所选择的存储器单元的输出的表示。输出电路150包括输出电路以将表示解译成数 据值,该数据值可包括下文在图2、图3、图4和图6中描述的各种増强电路。这些数据值可包 括具有与所需逻辑表示对应的电压电平的二进制值。如下文将讨论的,当从存储器阵列110 读取数据位时,输出电路150可减小或消除选择器元件对感测电压的影响。缓冲器160可包 括数字存储器元件,该数字存储器元件被包括以用于在将由输出电路150确定的数据位通 过数据链路161传输到一个或多个外部系统之前存储该数据位。在一些示例中,列解码器 130、感测电路140、输出电路150和缓冲器160的各部分可组合成电路块或在类似电路部件 上共享。 现在转到来自图1的可选的存储器单元111以及各种支持电路的详细具体实施,提 供了图2。图2表示交叉点存储器阵列中的单个“结”,以及相关联的行/列驱动器电路和存储 器单元。具体地,图2包括电路200,该电路包括电流控制电路210、电流镜212、输出电路220、 可选的MRAM单元230、行驱动器240和列驱动器241。可选的MRAM单元230可包括来自图1的可 选的存储器单元111的示例具体实施,其中图1的MTJ元件112和选择器元件113分别由MRAM 元件231和选择器238表示。可选的MRAM单元230可被称为“1S-1MTJ”型MRAM单元,其由单个 8 CN 111599393 A 说 明 书 4/11 页 选择器(S)和单个MTJ元件形成。可选的MRAM单元230可形成在交叉点存储器阵列的行/列结 处,诸如关于在图1中的行线114和列线115所看到的。因此,行线251可对应于图1中的行线 114,并且列线252可对应于图1中的列线115。图1的行/列结处的其他存储器单元可具有与 图2中所看到的类似的布置,但变化是可能的。 MRAM元件231包括MTJ元件232,该MTJ元件在该示例中是STT型MTJ元件。使用相应 的电脉冲擦除、写入和读取MTJ 232。然而,这些电脉冲在本质上通常是双极性的,这是指可 由列驱动器242和行驱动器241在MRAM元件231上以第一极性或第二极性施加的控制电压或 控制电流。为了防止在生成对应电脉冲时意外擦除、写入和读取所选择的行或列的其他 MRAM元件,包括了与MRAM元件231串联的选择器238。 选择器238是包括图2中的双极性选择器的两端子选择器元件。选择器238可包括 硫属元素化物双向阈值开关或易失性导电桥,但也可采用其他技术。一旦超过阈值条件(诸 如阈值电压(Vt))并且选择器238被放置成处于导电状态下,选择器238就在选择器238的两 个端子之间形成导电(例如,低相对电阻)桥。在选择器238被超过阈值条件激活之后,只要 选择器238上存在足够的电流或电压,则选择器238就保持处于相对于非启用状态具有低电 阻的启用状态。一旦不存在足够的电流或电压(诸如下降到低于滞后阈值),则选择器238就 变为非启用状态(高相对电阻)。然后,选择器238的两个端子之间的导电路径塌缩或去激 活。可在选择器238中控制滞后特性。选择器238所表现出的滞后量与施加到MRAM元件231的 电压直接相关。具体地,当‘导通’时,选择器238充当与包括MRAM元件231的MTJ232串联的电 压源。该电压源的量值对应于保持电压,在本文中称为偏置电压,在本文中也称为VOFFSET。该 偏置电压可干扰对MTJ 232的当前磁化状态的准确读取。 在图9中示出了选择器238的示例特征。图9包括示出选择器238在各种电压和电流 下的特性的曲线图900。曲线图900的纵轴对应于选择器电流,或当前通过选择器238的电 流。曲线图900的横轴对应于选择器电压或当前跨选择器238的电压。曲线图900的左下象限 和右上象限以显示选择器238的双极性特性。左下象限示出具有负选择器电流(-I选择器)的负 极性,而左上象限示出具有正选择器电流( I选择器)的正极性。在其他示例中,相关联的极性 可颠倒,并且选择器238的双极性质通常关于极性是对称的。 曲线图900示出了选择器238在负极性和正极性两种情况下的电流-电压(IV)曲 线。该IV曲线由图9中的曲线部分901-904表示。选择器238在曲线图900中表现出非线性响 应。选择器238的‘关断’状态对应于在低施加电压下的高器件电阻和低漏电流(Ilk)。该‘关 断’状态由曲线图900中的曲线部分903-904表示。选择器238的‘导通’状态对应于在高施加 电压(>Vt)下的低器件电阻,并且由曲线图900中的曲线部分901-902表示。Rson对应于对应 曲线部分的斜率,该Rson包括每种极性下选择器238的‘导通’电阻。选择器238表现出阈值切 换特性,其中阈值电压(Vt)一旦被超过(>Vt),则选择器238就从高电阻‘关断’状态(曲线部 分903-904)变为低电阻‘导通’状态(曲线部分901-902)。 选择器238的滞后特性也在曲线图900中示出。曲线图900中的滞后特性对应于通 过外推选择器‘导通’状态电流-电压(IV)曲线而获得的电压轴线上的点。具体地,该滞后对 应于施加电压可降至Vh(其低于Vt)并且之后Vt被超过的位置。另外,该滞后特性具有对应的 电流极限(Ih),低于该电流极限时,选择器可将状态切换至‘关断’状态。选择器238的实际 性能以及‘导通’和‘关断’电阻值将基于制造变化、器件尺寸和其他特定于具体实施的细节 9 CN 111599393 A 说 明 书 5/11 页 而变化。因此,选择器238在处于‘导通’状态时所表现出的偏置电压也可变化。本文的示例 提供了用于减小选择器238的偏置电压的影响以及补偿阵列中的不同选择器之间的偏置电 压变化的増强补偿技术。 返回图2,其示出了示例电路200。在操作中,由定位在电路200的“低”电位侧上的 电流镜212限制电流(ILIMIT)通过电路200的各部分。电路200的低电位侧在图2中被称为VLOW, 对应于电路的耦合到低电位或低电压(即在典型情况下为0V)的端部。由电流镜212所汲取 的电流基于由电流控制电路210设定的电流极限而变化,并且该极限值的控制在下文中更 详细地讨论。电流控制电路210因此被配置为限制通过可选的MRAM单元230的电流。在一个 实施方案中,控制电路210限制在可选的MRAM单元230的读取操作期间所采用的读取电流。 在操作中,由于晶体管213和214的栅极的特定耦合,电流镜212将由电流控制电路210设定 的任何电流极限从电流镜212的左手侧镜像到电流镜212的右手侧。该电流通过可选的MRAM 单元230和其他串联连接的电路和互连器(诸如未选择的行线和未选择的列线)而被汲取。 行驱动器241和列驱动器242耦合到相关联的行线251和列线252,它们与可选的MRAM单元 230形成了串联电路。 在电流(ILIMIT)的施加期间,在用于感测MTJ 232的状态的电流镜212处呈现出感测 电压(在本文中称为VSENSE)。该感测电压可表示为:V感测=V读取-V偏置-I极限(RS RMRAM),其表示为 图2中的公式203。VREAD作为供电电压施加到列驱动器242,VOFFSET是选择器238上的电压,RS是 与MTJ 232串联的线路和部件的串联电阻,并且RMRAM是MRAM元件231当前所表现出的电阻。 MRAM元件231当前所表现出的电阻(RMRAM)反映了MTJ 232的磁化状态,因此表示在MRAM元件 231内存储的数据或位值。 可选的MRAM单元230上的电压(VCOMBINED)对应于ILIMIT*RMRAM。ILIMIT通常设置为使得 VCOMBINED介于约0.1-0.3V之间,以保护免受读取干扰(读取操作期间的无意写入/编程)。因 此,VOFFSET的变化应小于约10-30mV。在实施过程中,难以将选择器制造成处于此类特定的 VOFFSET范围内。例如,如果选择器的偏置电压为1.3V,则将VOFFSET控制到10-30mV将意味着将 VOFFSET控制成处于<2.5%以内。有利的是,本文的示例补偿选择器(诸如图2所示的选择器 238)的偏置电压的变化。这些示例包括图3中的补偿电路320、图4中的补偿电路420,和图6 中的补偿620,以及其他示例。本文所呈现的示例基本上消除了选择器VOFFSET的变化。该放 大的边限可用于其他变化源,例如MRAM直径变化。本文提供的示例将可用于生产处于16- 64Gb范围内的独立MRAM产品,以用于DRAM替换。 下文示出了用于感测可选的MRAM单元232的MTJ 230的磁化状态的三个示例具体 实施。在每个示例性具体实施中,输出电路220具有用于感测VSENSE处的一个或多个电压的对 应配置,而电流控制电路210控制电流镜212以获得对应的ILIMIT量值。具体地,下面的示例施 加多个电流极限(ILIMIT)并感测VSENSE如何随着ILIMIT变化而变化。由于VOFFSET随着ILIMIT变化为 恒定的,因此可以在最终结果中补偿VOFFSET。在许多情况下,该补偿是指减少VOFFSET对VSENSE的 影响。这对应于上述公式中VSENSE相对于ILIMIT的数学导数,即公式203的导数。 提供图3以示出第一示例具体实施300。在图3中,输出电路220包括补偿电路320。 补偿电路320包括电容器321和电流感测电路322,该电流感测电路耦合至低电位(例如,接 地)。在该示例中,电容值为Ca的电容器321耦合到图2的VSENSE电气节点。此外,电流控制电路 210被配置为向电路200施加斜坡电流301。该斜坡电流301以恒定速率dILIMIT/dt使ILIMIT斜 10 CN 111599393 A 说 明 书 6/11 页 坡变化,如图3中的ILIMIT_RAMP所指示。从VSENSE通过电容器331传递到接地的电容器电流(ICAP) 对应于VSENSE的导数。具体地,ICAP=dVSENSE/dt=Ca*dILIMIT/dt*(RS RMRAM)。一旦确定了ICAP,则 就可基于所确定的RMRAM的值来确定MRAM单元231的磁化状态。有利地,感测ICAP而非VSENSE降 低或消除了公式203中的VOFFSET(以及相关联的选择器器件到器件变化)的影响。 在图2中,电流感测电路322可用于感测ICAP。在一个示例中,电流感测电路322可包 括电流镜,该电流镜类似于针对电流镜212所示的电流镜。电流镜的参考电流可用于感测 ICAP的状态。在另一个示例中,电流感测电路322可包括耦合到电容器321的端子的具有特定 电阻(诸如50-100千欧姆)的电阻器。然后电流感测电路322可使用比较器或其他类似电路 来感测该电阻器上的电压降。该电压降可用于确定ICAP。 然而,部分地由于感测ICAP的相对复杂性,图3中所示的具体实施具有挑战。输出电 路220的另一个示例具体实施400呈现于图4中。在图4中,针对ILIMIT的两个不同值来确定 VSENSE的样本。然后减去VSENSE的这两个样本以获得结果。该结果对应于公式203的离散微分 类型,然后用于确定MRAM单元231的磁化状态。与图3中的电路和技术一样,由图4中的电路 所确定的结果也减小或消除了公式203中的VOFFSET(以及相关联的选择器器件到器件变化) 的影响。 在图4中,输出电路220包括补偿电路420。补偿电路420包括若干基于晶体管的开 关元件,该基于晶体管的开关元件选择性地向电容器425和426提供存在于VSENSE上的电压。 在图4中,不执行如图3进行的对通过电容元件的电流的直接测量。相反,使用电容器425和 426减去VSENSE的两个不同值,以产生VOUT,这减小或消除了VOFFSET的影响。 第一开关元件(晶体管421)具有耦合到第一选择信号(S1)的栅极端子,并且第二 开关元件(晶体管422)具有耦合到第二选择信号(S2)的栅极端子。晶体管421-422的漏极端 子耦合到VSENSE。电容器425和426各自具有相应的电容值,即图4中的Cb和Cc。具体电容值将 基于具体实施而变化,但在本示例中Cb和Cc包含彼此相同的值。读取晶体管423和424包括读 出电路,该读出电路在Cb和Cc存储的电压之间执行减法运算,并且在VOUT上呈现合成电压。具 体地,晶体管423的栅极端子耦合到第一读取控制信号(READ A),并且晶体管424的栅极端 子耦合到第二读取控制信号(READ B)。晶体管421的源极端子耦合到电容器425的第一端子 和晶体管424的漏极端子。晶体管424的源极端子耦合到电容器426和晶体管422的源极端 子。晶体管423的源极端子和电容器426的第二极端子耦合到低电位,诸如接地或0V。VOUT呈 现来自补偿电路420的结果,该VOUT耦合到晶体管423的漏极端子。 在操作中,电流控制电路210被配置为向电路200施加阶跃电流401。该阶跃电流对 应于ILIMIT的第一恒定值,即ILIMIT_1,之后是ILIMIT的第二恒定值,即ILIMIT_2。在本示例中, ILIMIT_1大于ILIMIT_2,但是其他配置也是可能的。示例电流极限为ILIMIT_1的11微安(μA)的和 ILIMIT_2的2μA。电流控制电路210选择这些电流极限以通过电流镜212产生镜像电流,该电流 镜至少通过电路200中的MRAM元件231和选择器238以及相关联的行线和列线来汲取电流。 图5示出了详述补偿电路420的控制信令的时序图500。在图表500中,选择器238通 过超过阈值条件(诸如阈值电压或阈值电流)而改变为‘导通’状态。可在可选的MRAM单元 230上建立电压,这产生了高于选择器238的阈值电压(Vt)的电压,如图表500的曲线501中 所看到的。具体地,在该示例中,电压被建立为VBITLINE与VWORDLINE之间的差值或2.3V。VBITLINE 对应于由列驱动器242施加到列线252的电压。VWORDLINE对应于由行驱动器241施加到行线251 11 CN 111599393 A 说 明 书 7/11 页 的电压。一旦选择器238被放置成处于‘导通’状态下,则电流就可穿过选择器238。只要该电 流保持高于滞后电流值,则选择器238就将保持处于‘导通’状态或低电阻状态下。如果电流 下降到低于滞后电流值,则选择器就将变为‘关断’状态,并且将由于高电阻状态而停止传 递可测量的电流。 向通过可选的MRAM单元230的电流施加第一电流极限,即11μA的ILIMIT_1。该第一电 流极限可以在图表500的曲线503中看到。第一选择信号(S1)和第二选择信号(S2)保持在高 电压,该高电压控制相关联的晶体管(421、422)处于启用状态下,从而允许对应的电容器 (425、426)跟踪在各种电流极限时VSENSE上所呈现出的电压。具体地,如在曲线502中所看到 的,当施加ILIMIT_1时,第一选择信号(S1)被驱动到高电压(启用状态),该高电压控制晶体管 421将VSENSE上所呈现出的电压传递到节点432和电容器425。电容器425存储在ILIMIT_1时的该 VSENSE值,然后通过将栅极端子驱动到低电压(非启用状态)来禁用S1,以将电容器425与 VSENSE隔离。向通过可选的MRAM单元230的电流施加第二电流极限,即2μA的ILIMIT_2。该第二电 流极限可以在图表500的曲线503中看到。从ILIMIT_1到ILIMIT_2的转变可以是具有某一速度的 斜坡,该速度经选择以确保补偿电路420的期望操作定时,同时保持电磁干扰和振荡低于目 标水平。如在曲线504中所看到的,当施加ILIMIT_2时,第二选择信号(S2)被驱动到高电压(启 用状态),该高电压控制晶体管422将VSENSE上所呈现出的电压传递到节点431和电容器426。 电容器426存储在ILIMIT_2时的该VSENSE值,然后通过将栅极端子驱动到低电压(非启用状态) 来禁用S2,以将电容器426与VSENSE隔离。 一旦电容器425和426均已使用针对特定电流极限的特定VSENSE样本充电,则就可以 在存储于电容器425和426中的电压之间执行减法。首先,将READ A信号带到低电压以禁用 晶体管423(曲线505),同时将READ B信号带到高值以启用晶体管424(曲线506)。READ A信 号和READ B信号的这种配置允许通过晶体管424将存储在电容器425和426中的电压彼此相 减,并在VOUT处呈现合成电压。然后可以在VOUT处感测来自补偿电路420的输出或结果,如根 据图表500中的大致定时所示(感测)。VOUT处的该结果对应于对公式203的离散微分的计算, 然后用于确定MRAM单元231的磁化状态。 图5中的图表510示出了对补偿电路420和图表500使用上述该过程的模拟结果。在 图表510的模拟中用作选择器238的特定选择器是在85℃的环境温度下阈值电压(Vt)为 1.7V的双向阈值开关(OTS)。还示出了Cb和Cc的示例电容值,对于图表510中的相关联的曲 线,示例值为10毫微微法拉(fF)和30fF。此外,示出了存储在相关联的MRAM元件中的每个二 进制值的曲线,如由对应的MTJ元件的并行磁化状态和反并行磁化状态所指示。 在图表510中,曲线511和512示出了作为选择器238的VOFFSET的函数,在不使用上文 关于图4和图表500所描述的过程的情况下的VSENSE感测窗口。如可以看出的,表现出VSENSE随 着VOFFSET变化有较大变化。曲线513-516示出了使用电容减法的补偿电路420的电压VOUT。对 于曲线511-512,该电压VOUT随着VOFFSET变化的变化要小得多,并且与曲线511和512所示的没 有电容减法电路的情况下的边限 /-<1.2V相比,可以获得边限VOFFSET> /-0.2V。对于选择 器238,使用比该模拟中使用的特定选择器具有更低漏的选择器将获得甚至更好的结果。 图4和图5中存在的电路、配置和操作可以在另一个示例具体实施中进一步简化。 图6呈现了该示例具体实施600。具体实施600包括补偿电路620,该补偿电路采用单个电容 器622和单个开关元件(晶体管621)。在图6中,针对ILIMIT的两个不同值来确定VSENSE的样本。 12 CN 111599393 A 说 明 书 8/11 页 使用电容器622减去VSENSE的两个样本以获得结果。该结果对应于公式203的离散微分类型, 然后用于确定MRAM单元231的磁化状态。与图3和图4中的电路和技术一样,由图6中的电路 所确定的结果也减小或消除了公式203中的VOFFSET(以及相关联的选择器器件到器件变化) 的影响。在图6中,不执行如图3进行的对通过电容元件的电流的直接测量。相反,在电容器 622内减去VSENSE的两个不同值,以产生VOUT,这减小或消除了VOFFSET的影响。 在图6中,输出电路220包括补偿电路620。存在于VSENSE上的电压耦合到电容器622 的第一端子。补偿电路620包括基于单个晶体管的开关元件(621),该基于单个晶体管的开 关元件将电容器622的第二端子选择性地耦合到低电位(诸如接地或0V)或与低电位解耦 合。晶体管621具有耦合到第一选择信号(S1)的栅极端子。晶体管621的漏极端子耦合到电 容器622的第二端子和VOUT,并且晶体管621的源极端子耦合到低电位。电容器622具有对应 的电容值,即图6中的Cd。具体电容值将基于具体实施而变化。VOUT呈现来自补偿电路620的 结果,该VOUT耦合到晶体管621的漏极端子。补偿电路620中不需要单独的读出电路,诸如晶 体管423和424。相反,晶体管621和电容器622包括读出电路,并且包括补偿电路。 在操作中,电流控制电路210被配置为向电路200施加阶跃电流601。该阶跃电流对 应于ILIMIT的第一恒定值,即ILIMIT_1,之后是ILIMIT的第二恒定值,即ILIMIT_2。在本示例中, ILIMIT_1大于ILIMIT_2,但是其他配置也是可能的。示例电流极限为ILIMIT_1的11微安(μA)和 ILIMIT_2的2μA。电流控制电路210选择这些电流极限以通过电流镜212产生镜像电流,该电流 镜至少通过电路200中的MRAM元件231和选择器238以及相关联的行线和列线来汲取电流。 图7示出了详述补偿电路620的控制信令的时序图700。在图表700中,选择器238通 过超过阈值条件(诸如阈值电压或阈值电流)而改变为‘导通’状态。可在可选的MRAM单元 230上建立电压,这产生了高于选择器238的阈值电压(Vt)的电压,如图表700的曲线701中 所看到的。具体地,在该示例中,电压被建立为VBITLINE与VWORDLINE之间的差值或2.3V。VBITLINE 对应于由列驱动器242施加到列线252的电压。VWORDLINE对应于由行驱动器241施加到行线251 的电压。一旦选择器238被放置成处于‘导通’状态下,则电流就可穿过选择器238。只要该电 流保持高于滞后电流值,则选择器238就将保持处于‘导通’状态或低电阻状态下。如果电流 下降到低于滞后电流值,则选择器就将变为‘关断’状态,并且将由于高电阻状态而停止传 递可测量的电流。 向通过可选的MRAM单元230的电流施加第一电流极限,即11μA的ILIMIT_1。该第一电 流极限可以在图表700的曲线703中看到。第一选择信号(S1)在第一电流极限期间保持在高 电压,该高电压控制相关联的晶体管621处于启用状态下,从而允许对应的电容器622跟踪 在第一电流极限时VSENSE上所呈现的电压。具体地,如在曲线702中所看到的,当施加ILIMIT_1 时,第一选择信号(S1)被驱动到高电压(启用状态),该高电压控制晶体管621耦合到低电 位。电容器622可充电至ILIMIT_1期间VSENSE上所呈现的电压。在电流控制电路210施加第二电 流极限(ILIMIT_2)之前,第一选择信号(S1)被驱动到如在曲线703中所看到的那样低,从而将 晶体管621放置成处于非启用状态下,并且使电容器622的第二端子相对于低电位浮接。然 而,电容器622的第一端子仍然耦合到VSENSE。一旦电流控制电路210施加第二电流极限 (ILIMIT_2),则从第一电流极限(ILIMIT_1)期间VSENSE的初始取样值中连续减去VSENSE处所呈现的 电压。在电流从ILIMIT_1转变为ILIMIT_2之后,则VOUT处电容器622的第二端子处的电压对应于补 偿电路620的结果。然后可以在VOUT处感测来自补偿电路620的输出或结果,如根据图表700 13 CN 111599393 A 说 明 书 9/11 页 中的大致定时所示(感测)。VOUT处的该结果对应于对公式203的离散微分的计算,然后用于 确定MRAM单元231的磁化状态。 图7中的图表710示出了对补偿电路620和图表700使用上述该过程的模拟结果。在 图表510的模拟中用作选择器238的特定选择器是在85℃的环境温度下阈值电压(Vt)为 1.7V的双向阈值开关(OTS)。图710中的Cd的示例电容值被设定为10fF,但也可采用其他值。 此外,图表710示出了采用两个电容器的补偿电路420与采用一个电容器的补偿电路620之 间的比较。补偿电路620的基于单个电容器的电路给出了比补偿电路420的两电容器电路甚 至更不依赖于VOFFSET的结果。有利地,与补偿电路420相比,补偿电路620具有更不复杂的配 置、更小的部件计数、呈现出对VSENSE和VOUT的更小总电容,并且可产生更快的结果。 在图表710中,曲线711和713显示出作为选择器238的VOFFSET的函数,使用补偿电路 420时的VSENSE感测窗口。曲线712和714显示出作为选择器238的VOFFSET的函数,使用补偿电路 620时的VSENSE感测窗口。如可以看出的,曲线711和713表现出比曲线712和714更大的随 VOFFSET变化的VSENSE变化。对于曲线712和714,该电压VOUT随VOFFSET变化的变化要小得多,并且 与曲线711和713中所示的使用补偿电路420的双电容器减法电路的情况下的边限 /-< 0.2V相比,使用补偿电路620的单电容器电路可以获得边限VOFFSET> /-0 .1V。对于选择器 238,使用比该模拟中使用的特定选择器具有更低漏的选择器将获得甚至更好的结果。 现在呈现图8来说明本文所讨论的各种电路和系统的操作。图8的操作是在图2的 元件的情境下讨论的,但是可以替代地采用不同的元件。在图8中,对从可选的MRAM单元230 读取的电压执行补偿。该补偿减少了选择器238对由电流通过可选的MRAM单元230而产生的 电压的影响。具体地,选择器238当被启用时具有特定的VOFFSET属性,该属性可以从器件到器 件以及基于穿过选择器238的电流而变化。因此,可能很难读取由MTJ 232组成的MRAM元件 231的电压。 虽然不是必需的,但是一些示例可以在读取操作之前执行擦除操作或写入操作。 具体地,可以任选地将MRAM元件321擦除到初始状态,然后可以将期望的数据值写入或编程 到MRAM元件321中。在另一示例中,诸如在操作803-805中讨论的,可以在擦除或写入操作之 前执行读取操作,以确定MRAM元件321的当前状态。如果MRAM元件321处于期望状态下,则可 省略擦除或写入操作。在其他示例中,可以在不擦除到初始状态或者不经由读取操作检查 先前编程的状态的情况下对MRAM元件321进行写入或编程。 当需要擦除操作时,则可执行任选的操作801。在操作801中,首先从可选的MRAM单 元230擦除数据。这可通过以下方式来实现:驱动可选的MRAM单元230上的电压,该电压超过 将选择器238切换到启用状态或导电状态所需的阈值电压(Vt)。一旦处于导电状态下,则选 择器238就可传递电流,该电流用于擦除可选的MRAM单元230内的串联连接的MTJ232。该擦 除操作将MTJ 232的磁化状态放置成处于期望的初始状态下,该期望的初始状态可以表示 二进制‘1’或‘0’以及其他值。该状态对应于MTJ232的并行(P)或反并行(AP)状态,其中相对 较大的电流可以在优选方向或极性上穿过MTJ 232,以根据电流极性迫使MTJ 232进入初始 状态(例如,P或AP)下。因为选择器238包括双向或双极选择器元件,所以选择器238可以为 MTJ 232传递任一极性的电流。 当被采用到MRAM单元阵列中时,诸如图1所示,则特定的列线和行线可被选择用于 到达目标MRAM单元以进行擦除。在交叉点存储器阵列中,诸如图1所示,每个存储器单元通 14 CN 111599393 A 说 明 书 10/11 页 常是在列线和行线的每个结处单独可选的。可采用各种列选择电路和行选择电路来控制选 择操作。 当需要写入操作时,则可执行任选的操作802。可选的MRAM单元230可具有写入或 编程到MRAM元件321中的数据值。在可选操作802中,通过以下方式来写入数据:驱动可选的 MRAM单元230上的电压,该电压超过将选择器238切换到启用状态或导电状态所需的阈值电 压(Vt)。一旦处于导电状态下,则选择器238就可传递电流,该电流用于对可选的MRAM单元 230内的串联连接的MTJ 232进行编程。该写入操作将MTJ232的磁化状态放置成处于期望的 状态下以表示数据值,该数据值可以包括二进制‘1’或‘0’以及其他值。这些数据值或数据 状态对应于MTJ 232的并行(P)或反并行(AP)状态,其中电流可以在优选方向或极性上穿过 MTJ 232,以根据电流极性迫使MTJ 232进入期望状态(例如,P或AP)下。因为选择器238包括 双向或双极选择器元件,所以选择器238可以为MTJ 232传递任一极性的电流。 现在转到对增强的读取操作的讨论,可选的MRAM单元230可以具有从MRAM元件321 读取的数据值。在操作803中,通过以下方式来从可选的MRAM单元230读取数据:驱动可选的 MRAM单元230上的电压,该电压超过将选择器238切换到启用状态或导电状态所需的阈值电 压(Vt)。一旦处于导电状态下,则选择器238就可传递电流,该电流用于读取可选的MRAM单 元230内的串联连接的MTJ 232的当前磁化状态。该读取操作在MTJ 232上产生电压,该电压 取决于先前编程的磁化状态,该先前编程的磁化状态表示数据值,该数据值可以包括二进 制‘1’或‘0’以及其他值。这些数据值或数据状态对应于MTJ 232的并行(P)或反并行(AP)状 态,其中电流可以在优选的方向或极性上穿过MTJ 232以产生MTJ 232上的电压,该电压反 映当前磁化状态。因为选择器238包括双向或双极选择器元件,所以选择器238可以为MTJ 232传递任一极性的电流。 然而,在图2的具体实施中,读取电流以针对ILIMIT所指示的极性传递,即从列驱动 器242通过列线252、通过串联连接的选择器238和MRAM元件231、通过行线251,以及行驱动 器241。在操作中,可以采用电压来将选择器238改变成导电状态,但是随后使用电流控制电 路210结合电流镜212来限制由选择器238和MRAM元件231传递的电流的量值。以各种方式限 制该电流,以在VSENSE处产生一个或多个电压在第一示例中,如图3所示,采用斜坡电流极限 301,该斜坡电流极限在VSENSE处产生斜坡电压。补偿电路320可以用来接收VSENSE并补偿选择 器238的VOFFSET属性。该补偿有利地减小了VOFFSET对由施加的读取电流在MTJ 232上产生的电 压的影响,并且减小了对选择器238的器件到器件可变性的影响。 在第二示例中,如图4所示,采用阶跃电流极限401,该阶跃电流极限在VSENSE处产生 两个相继电压。补偿电路420可用于接收VSENSE,暂时存储VSENSE的每个值。通过减去从第二电 流极限存储的VSENSE的第二值,来减小从第一电流极限存储的VSENSE的第一值。因此补偿电路 420可以用该经减去的结果来补偿选择器238的VOFFSET属性。类似于图3的补偿,图4中执行的 补偿有利地减小了VOFFSET对由施加的读取电流在MTJ 232上产生的电压的影响,并且减小了 对选择器238的器件到器件可变性的影响。然而,补偿电路420以比补偿电路320更低的电路 复杂性实现了该补偿。 在第三示例中,如图6所示,采用阶跃电流极限601,该阶跃电流极限在VSENSE处产生 两个相继电压。补偿电路620可用于接收VSENSE,暂时存储第一电流极限期间VSENSE的第一值, 并且在单个电容器内从该VSENSE的第一(存储)值减去第二电流极限期间VSENSE的第二值。因 15 CN 111599393 A 说 明 书 11/11 页 此补偿电路620可以用该经减去的结果来补偿选择器238的VOFFSET属性。类似于图4的补偿, 图6中执行的补偿有利地减小了VOFFSET对由施加的读取电流在MTJ232上产生的电压的影响, 并且减小了对选择器238的器件到器件可变性的影响。然而,补偿电路620以比甚至补偿电 路420更低的电路复杂性实现了该补偿。 如上所述,基于从各种电流极限产生的感测电压,输出电路220确定(804)输出电 压(VOUT)。可以包括各种补偿电路来补偿VOFFSET对MTJ 232上产生的电压的影响。然而,上述 补偿电路的结果通常包括VSENSE的导数或微分型式,减去或消除了VOFFSET的影响。这可由图2 的公式203的导数或微分形式表示。 然后,输出电路220基于来自补偿电路的输出电压来确定(805)可选的MRAM单元 230中的MRAM元件231中的数据的值。在一些示例中,输出电路220计算对VOUT的反导数、积分 或其他数学运算,以确定MRAM元件231中的MTJ 232的磁化状态。在另外的示例中,输出电路 220可直接解译VOUT以确定MRAM元件231中的MTJ 232的磁化状态。例如,如果MRAM元件231中 的MTJ 232的磁化状态具有两个可能的值(例如,在一个示例中,‘1’和‘0’对应于并行和反 并行状态),则一旦从VOUT减小或去除VOFFSET,输出电路220就可以确定两个状态之间的电压 不同。因此,VOUT的两个不同电压将各自对应于MRAM元件231中MTJ 232的特定磁化状态,并 因此对应于不同的数据值。然后,数据值可与针对一个或多个外部系统所指示的不同逻辑 水平、电压电平或其他表示相关。在另外的示例中,缓冲器160可用于在将数据值传输到一 个或多个外部系统之前存储所述数据值。 所包括的描述和附图描绘了教导本领域技术人员如何制作和使用最佳模式的具 体实施方案。出于教导发明性原理的目的,已经简化或省略了一些常规的方面。本领域技术 人员将理解来自落入本公开范围内的这些实施方案的变型。本领域技术人员还将理解,上 述特征可以以各种方式组合以形成多个实施方案。因此,本公开不受上述具体实施方案的 限制,而是仅受权利要求及其等同物的限制。 16 CN 111599393 A 说 明 书 附 图 1/9 页 图1 17 CN 111599393 A 说 明 书 附 图 2/9 页 图2 18 CN 111599393 A 说 明 书 附 图 3/9 页 图3 19 CN 111599393 A 说 明 书 附 图 4/9 页 图4 20 CN 111599393 A 说 明 书 附 图 5/9 页 图5 21 CN 111599393 A 说 明 书 附 图 6/9 页 图6 22 CN 111599393 A 说 明 书 附 图 7/9 页 图7 23 CN 111599393 A 说 明 书 附 图 8/9 页 图8 24 CN 111599393 A 说 明 书 附 图 9/9 页 图9 25












