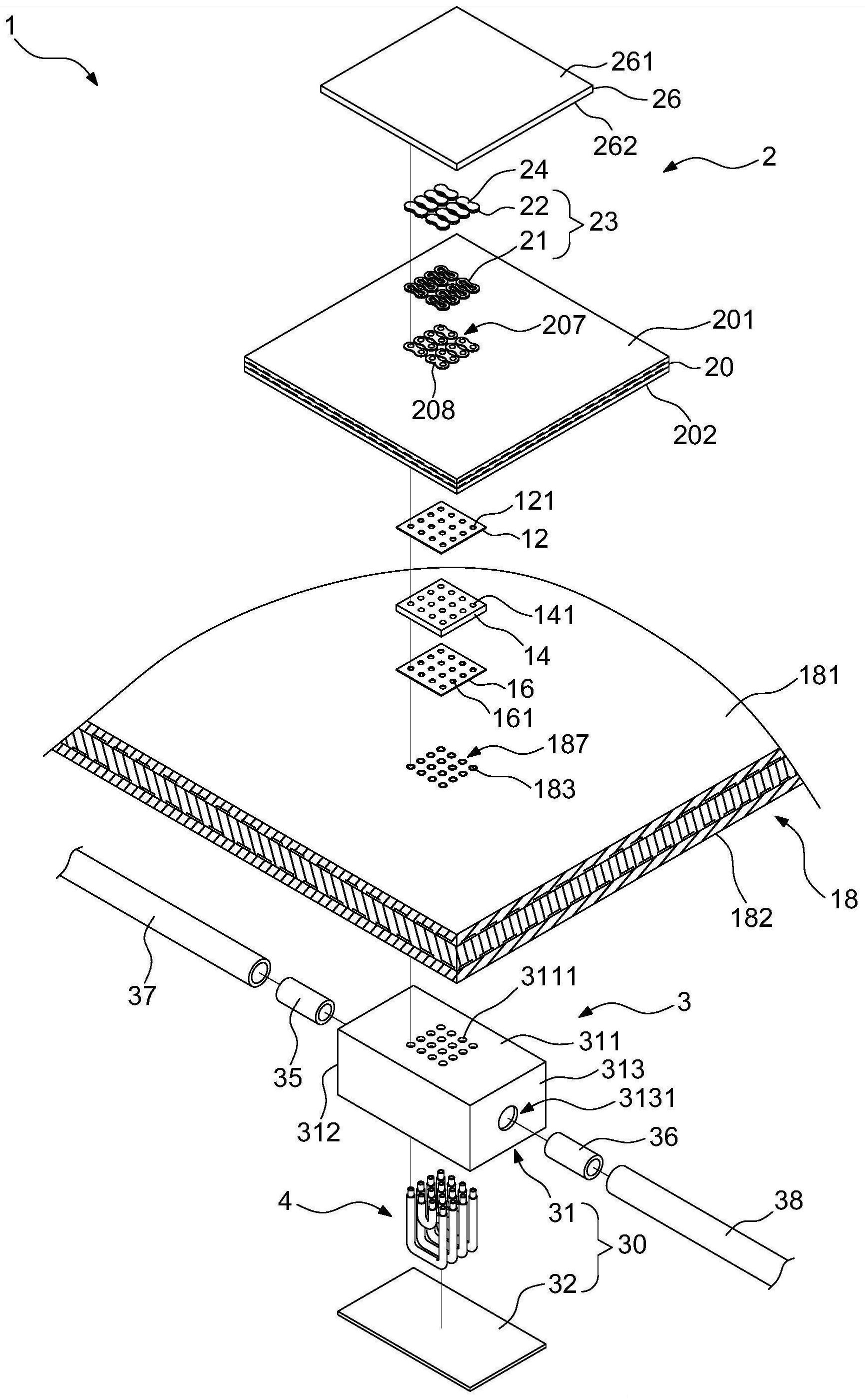
技术摘要:
半导体封装结构包含封装衬底及半导体裸片。所述封装衬底包含延伸穿过所述封装衬底的多个中空通孔。所述半导体裸片电连接到所述封装衬底。所述中空通孔安置于所述半导体裸片下方。
背景技术:
半导体封装结构的规范可包含高速数据传输容量、高数据容量及较小占用面积。 散热也是此类半导体封装结构的一个问题。在操作期间,高速数据传输可导致产生大量热 量并且可使半导体封装结构的温度升高。归因于半导体封装结构的小尺寸,可能难以耗散 所述热量。如果热量无法有效地耗散,则半导体封装结构的性能可降低,或者半导体封装结 构可能损坏或呈现为无法操作。
技术实现要素:
在一些实施例中,半导体封装结构包含封装衬底及半导体裸片。所述封装衬底包 含延伸穿过所述封装衬底的多个中空通孔。所述半导体裸片电连接到所述封装衬底。所述 中空通孔安置于所述半导体裸片下方。 在一些实施例中,电子装置包含半导体封装结构、主衬底及散热装置。半导体封装 结构包含封装衬底及半导体裸片。所述封装衬底包含延伸穿过所述封装衬底的多个第一中 空通孔。所述半导体裸片电连接到所述封装衬底。所述第一中空通孔安置于所述半导体裸 片下方。所述主衬底电连接到所述封装衬底。所述主衬底包含延伸穿过所述主衬底的多个 第二中空通孔,并且所述第二中空通孔与所述第一中空通孔对准。所述散热装置用于耗散 由所述半导体裸片产生的热量。所述热量通过所述第二中空通孔及所述第一中空通孔传 输。 附图说明 当结合附图阅读时,易于根据以下详细描述理解本公开的一些实施例的各方面。 应注意,各种结构可能未按比例绘制,且出于论述清楚起见,可任意增大或减小各种结构的 尺寸。 图1说明根据本公开的一些实施例的电子装置的分解立体图。 图2说明图1的半导体封装结构的分解立体图。 图3说明图2的封装衬底及帽盖结构的部分放大的截面图。 5 CN 111584447 A 说 明 书 2/11 页 图4说明图1的半导体封装结构的截面图。 图5说明图1的第一弹性层、中间块及第二层的立体图。 图6说明图1的第一弹性层、中间块、第二层及主衬底的组合件的部分放大的立体 截面图。 图7说明图1的散热装置的组合截面图。 图8说明图1的U形管的立体图。 图9说明图1的U形管及主衬底的组合件的立体截面图。 图10说明图1的电子装置的组合截面图。 图11说明根据本公开的一些实施例的电子装置的分解立体图。 图12说明图11的U形管的立体图。 图13说明图11的U形管、主衬底及半导体封装结构的组合立体截面图。 图14说明图11的散热装置、U形管及主衬底的组合截面图。 图15说明图11的电子装置的组合截面图。 图16说明根据本公开的一些实施例的电子装置的分解立体图。 图17说明图16的顶部U形管的立体图。 图18说明图16的半导体封装结构的立体图。 图19说明图16的顶部U形管、半导体封装结构、主衬底及放热板的组合截面图。 图20说明图16的放热板及底部U形管的分解立体图。 图21说明图16的电子装置的组合截面图。 图22说明根据本公开的一些实施例的电子装置的分解立体图。 图23说明图22的顶部连接元件的分解立体图。 图24说明图22的半导体封装结构的截面图。 图25说明图22的直管的立体图。 图26说明图22的主衬底、半导体封装结构及直管的组合截面图。 图27说明图22的底部连接元件的底部分解立体图。 图28说明图27的底部连接元件的组合截面图。 图29说明图22的电子装置的组合截面图。












