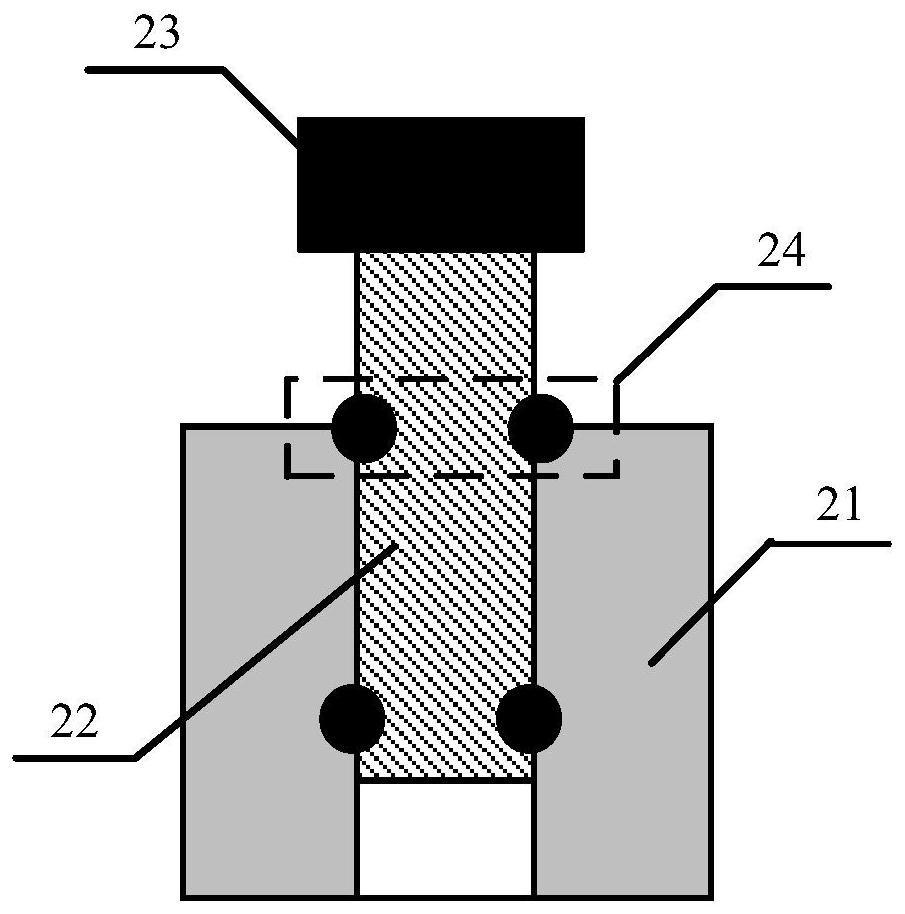
技术摘要:
本发明公开了一种隔离阀及半导体制造装置,隔离阀包括阀体、阀轴、阀门和唇形密封圈,阀门设置在阀轴的第一端,阀轴通过阀体提供的动力带动阀门沿轴向运动,唇形密封圈设置在阀体的动力部件与目标部件的接触部位,目标部件为阀门移动时相较于动力部件运动的部件。这样 全部
背景技术:
半导体的制造通常涉及多种工艺,需要多个腔室,包括预载腔室Load Lock Module、传送腔室Transfer Module、工艺腔室Process Module等,这些腔室有些需要提供 真空环境。现有的半导体制造设备通常设置各个工艺对应的腔室,在晶圆完成相关的工艺 后,需要转移至下一步工艺,这样,晶圆需要在多个腔室中传输,需要对应的两个相邻腔室 间连通,在传输完成后进行下一步工艺步骤时,对应的两个相邻腔室间相互隔离,互不影 响。现有技术通常采用隔离阀来控制两个相邻腔室间的连通与隔离,隔离阀在进行开关操 作时,如果密封不好,可能会导致腔室中的气体泄漏或者混入大气,导致腔室中的气体和气 压环境被破坏。目前由于半导体制造装置中的隔离阀上部件之间相对运动较频繁,易导致 气体容易泄露,密封效果不好。
技术实现要素:
本发明实施例提供一种隔离阀及半导体制造装置,用于提高密封效果。 第一方面,本发明提供了一种隔离阀,包括:阀体、阀轴、阀门和唇形密封圈,所述 阀门设置在所述阀轴的第一端,所述阀轴通过所述阀体提供的动力带动所述阀门沿轴向运 动,所述唇形密封圈设置在所述阀体的动力部件与目标部件的接触部位,用于对隔离的腔 室进行密封,所述目标部件为所述阀门移动时相较于所述动力部件运动的部件。 可选的,所述动力部件为所述阀体中容纳所述阀轴的气缸,所述目标部件为所述 阀轴,所述阀轴的第二端放置于所述气缸内,所述阀轴外壁与所述气缸内壁间设置有所述 唇形密封圈。 可选的,所述气缸中穿设有所述阀轴的气缸口处设置有所述唇形密封圈。 可选的,所述气缸的中间位置处设置有所述唇形密封圈,所述中间位置为将所述 阀轴推动至所述阀门关闭的位置处时所述阀轴的第二端在所述气缸中所处的位置。 可选的,所述阀体包括风箱结构,所述动力部件为所述风箱结构,所述风箱结构的 第一端与所述阀轴的第二端固定连接,所述风箱结构的第二端与固定件连接,所述目标部 件为所述固定件,所述风箱结构的第二端与所述固定件间设置有所述唇形密封圈。 可选的,所述风箱结构的第二端通过法兰盘与所述固定件连接,所述唇形密封圈 设置于所述法兰盘与所述风箱结构之间。 可选的,所述唇形密封圈采用经阳极氧化处理后的铝制唇形密封圈。 第二方面,本发明提供了一种半导体制造装置,包括至少两个腔室,相邻两个腔室 间设置有前述第一方面所述的隔离阀。 可选的,所述两个腔室包括预载腔室和工艺腔室。 本申请实施例中的上述一个或多个技术方案,至少具有如下一种或多种技术效 3 CN 111577915 A 说 明 书 2/5 页 果: 本申请实施例中的隔离阀,包括:阀体、阀轴、阀门和唇形密封圈,阀门设置在阀轴 的第一端,阀轴通过阀体提供的动力带动阀门沿轴向运动,唇形密封圈设置在阀体的动力 部件与目标部件的接触部位,用于对隔离的腔室进行密封,目标部件为阀门移动时相较于 动力部件运动的部件。这样,在隔离阀中容易出现泄漏的上述位置设置唇形密封圈,用于对 隔离腔室进行密封。由于隔离阀中的阀轴需要进行往复的运动来控制阀门开启或关闭,导 致密封介质压力会随之变化。采用唇型密封圈进行密封时,依靠唇部紧贴密封耦合件表面, 阻塞泄漏通道而获得密封效果。唇形密封圈的密封压紧力是随介质压力的改变而变化的, 当被密封介质压力增大时,唇口被撑开,更加紧密地与密封面贴合,密封性进一步增强。这 样,能够确保在阀轴往复运动时,唇形密封圈始终适应介质压力的变化,并且,可以通过唇 部撑开、变形补偿小的磨损量,保证隔离阀的密封效果和使用寿命。 附图说明 图1为本申请第一实施例中相邻腔室间设置隔离阀的示意图; 图2为本申请第一实施例提供的气缸型的隔离阀的结构示意图; 图3为本申请第一实施例提供的风箱型的隔离阀的结构示意图。












