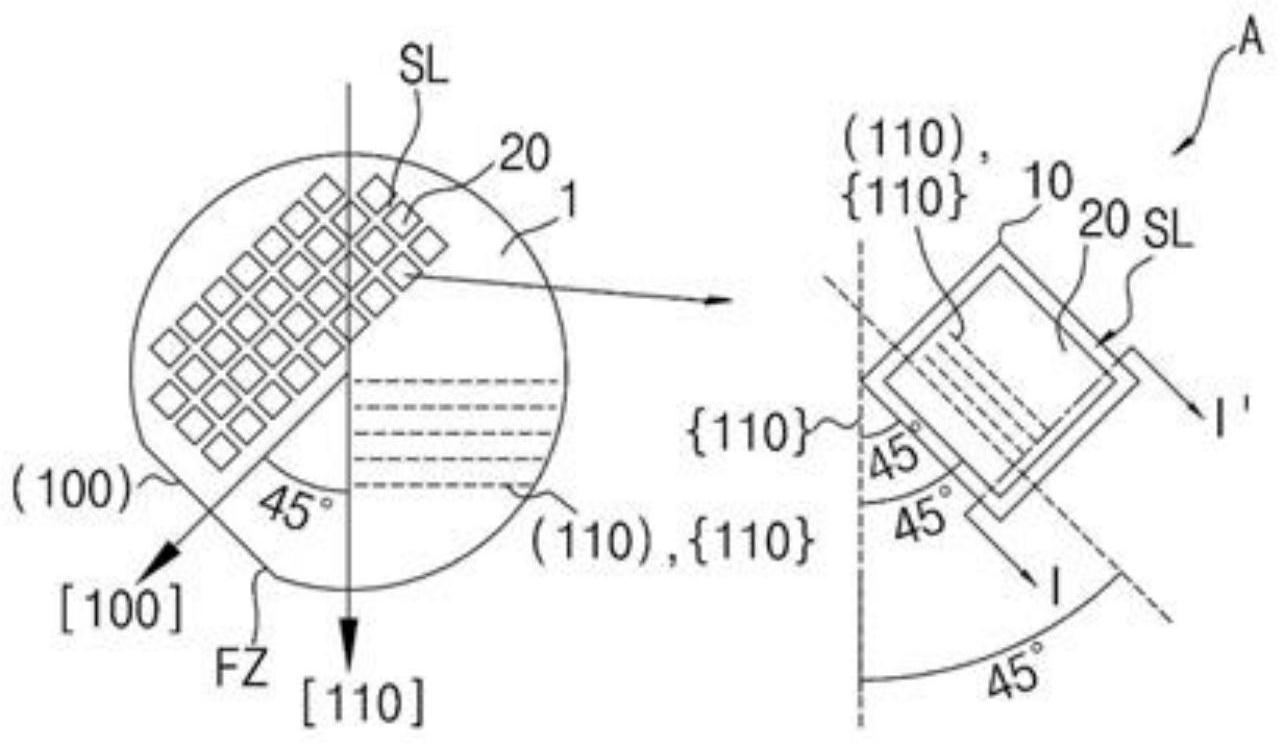
技术摘要:
本发明提供一种半导体封装件及制造半导体封装件的方法。半导体封装件包含:基底,具有硅晶体结构;以及至少一个半导体芯片,设置于基底上且具有上表面、下表面以及多个侧表面,其中多个侧表面不同于基底的解理面。
背景技术:
晶片可以划分为芯片区域和用于标识芯片区域的划片槽区域,且可包含显示晶片 的晶体结构的平坦区,半导体芯片在所述芯片区域中布置于晶片的表面上。由于无法用裸 眼辨识的晶片的晶体结构,因此在晶片的平坦区中,通过沿特定晶面切割来使晶片的外圆 周表面的一部分平坦,以显示晶片的晶体取向。通常,划片槽平行于或垂直于平坦区。 晶片级封装件可通过以下来形成:将半导体芯片安装在晶片的表面上;以及执行 切割划片槽区域的切割工艺以使半导体芯片彼此分隔。在晶片级封装件的制造期间,可能 因半导体芯片的冲击或因外来物质而对晶片施加弯曲力。裂纹可由于弯曲力而出现在晶片 中,且主要在晶片的晶体取向上传播。
技术实现要素:
本发明概念的实例实施例涉及提供一种半导体封装件,所述半导体封装件能够在 晶片级封装件的制造期间阻止裂纹的传播,所述裂纹由因将半导体芯片安装在晶片上时产 生的冲击或因外来物质而对晶片施加的弯曲力导致。 根据实例实施例,提供一种半导体封装件,所述半导体封装件包含:缓冲基底,具 有硅晶体结构;以及至少一个半导体芯片,设置于缓冲基底上且具有上表面、下表面以及多 个侧表面,其中多个侧表面相对于缓冲基底的解理面(cleavage planes)成倾斜角。 根据实例实施例,提供一种半导体封装件,所述半导体封装件包含:硅基底,具有 硅晶体结构和作为主表面的{100}晶面;以及半导体芯片,设置于硅基底上且具有四边形的 上表面,其中半导体芯片具有外侧表面,所述外侧表面在以平面图查看时相对于硅晶体结 构的<110>晶体取向形成倾斜角。 根据实例实施例,提供一种制造半导体封装件的方法,所述方法包含:制备缓冲基 底,所述缓冲基底具有硅晶体结构和作为主表面的(100)晶面;在缓冲基底上布置半导体芯 片;形成模制构件以覆盖缓冲基底和半导体芯片;以及通过切割模制构件和缓冲基底来形 成单独半导体封装件,使得单独半导体封装件中的每一个包含至少一个半导体芯片,其中 在缓冲基底上的半导体芯片的布置包含布置半导体芯片使得半导体芯片的外侧表面相对 于<110>晶体取向形成45°角。 4 CN 111599780 A 说 明 书 2/8 页 附图说明 图1是示出根据本发明概念的实例实施例的晶片和半导体芯片的布局以及从晶片 中个别化的半导体封装件的示意性平面图。 图2是沿图1的线I-I'截取的截面图。 图3是示出根据本发明概念的实例实施例的晶片和半导体芯片的布局以及从晶片 中个别化的半导体封装件的示意性平面图。 图4是示出根据本发明概念的实例实施例的晶片和半导体芯片的布局以及从晶片 中个别化的半导体封装件的示意性平面图。 图5到图10是示意性地示出根据本发明概念的实例实施例的制造半导体封装件的 方法的图,其中图6是沿图5的线II-II'截取的截面图,图8是沿图7的线III-III'截取的截 面图,且图10是沿图9的线IV-IV'截取的截面图。 附图标号说明 1、2:晶片; 10:缓冲基底/基底; 20、21、22、23、24、200:半导体芯片; 31、32、140、230:连接凸块; 45°:倾斜角; 50:绝缘层; 60:模制构件; 100:硅晶片/晶片/基底; 110:互连层/布线层; 120、V1、V2:硅通孔/TSV; 130:连接电极; 400:保护层; 410:离型层; 420:粘合层; 440:研磨器; 500:晶片载体; A、B、C:半导体封装件; As、Bs、Cs、Ds:外侧表面; FZ:平坦区; I-I'、II-II'、III-III'、IV-IV':线; SL:划片槽; SRAM:静态RAM。












